
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
WYTWARZANIE
WYTWARZANIE
ULTRACIENKICH WARSTW
ULTRACIENKICH WARSTW
dr in
dr in
ż
ż
. Aleksander Werbowy
. Aleksander Werbowy
materiały do wykładu –
TYLKO DO UŻYTKU WEWNĘTRZNEGO,
NA PRAWACH RĘKOPISU !
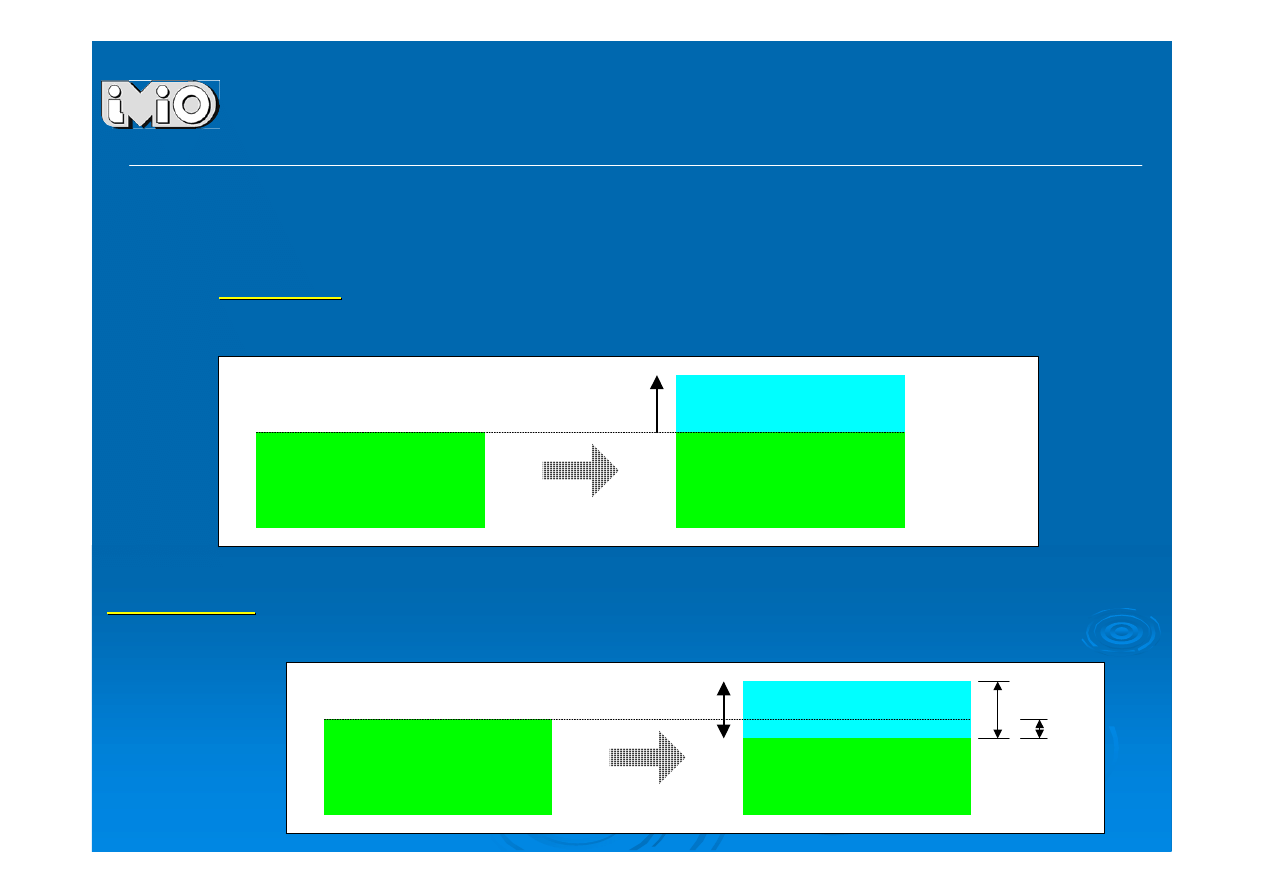
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Epitaksja
Epitaksja
vs
vs
. endotaksja
. endotaksja
podłoże
podłoże
warstwa
wzrost
Epitaksja
Epitaksja
: warstwa narasta tylko w jednym kierunku, w
: warstwa narasta tylko w jednym kierunku, w
„
„
g
g
ó
ó
r
r
ę
ę
”
”
,
,
poczynaj
poczynaj
ą
ą
c od powierzchni pod
c od powierzchni pod
ł
ł
o
o
ż
ż
a
a
–
–
np
np
. osadzanie SiO
. osadzanie SiO
2
2
Endotaksja
Endotaksja
: warstwa narasta w dw
: warstwa narasta w dw
ó
ó
ch kierunkach, od pod
ch kierunkach, od pod
ł
ł
o
o
ż
ż
a (jak w epitaksji),
a (jak w epitaksji),
ale r
ale r
ó
ó
wnie
wnie
ż
ż
w jego g
w jego g
łą
łą
b (
b (
„
„
konsumpcja
konsumpcja
”
”
pod
pod
ł
ł
o
o
ż
ż
a)
a)
–
–
np
np
. utlenianie powierzchni Si
. utlenianie powierzchni Si
(
(
x
x
0
0
≅
≅
0,44
0,44
x
x
)
)
podłoże
podłoże
warstwa
wzrost
x
x
0

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Techniki CVD
Techniki CVD
Proces syntezy materia
Proces syntezy materia
ł
ł
u w wyniku reakcji/proces
u w wyniku reakcji/proces
ó
ó
w
w
chemicznych zachodz
chemicznych zachodz
ą
ą
cych pomi
cych pomi
ę
ę
dzy lotnymi
dzy lotnymi
prekursorami. Reakcje te to dysocjacja i/lub reakcje
prekursorami. Reakcje te to dysocjacja i/lub reakcje
chemiczne aktywowane termicznie,
chemiczne aktywowane termicznie,
promienio
promienio
-
-
waniem
waniem
elektromagnetycznym b
elektromagnetycznym b
ą
ą
d
d
ź
ź
w
w
ś
ś
rodowisku
rodowisku
plazmy. Maj
plazmy. Maj
ą
ą
one charakter
one charakter
homogeniczny
homogeniczny
(prze
(prze
-
-
biegaj
biegaj
ą
ą
w obj
w obj
ę
ę
to
to
ś
ś
ci gazu) i/lub
ci gazu) i/lub
heterogeniczny
heterogeniczny
(zachodz
(zachodz
ą
ą
na lub w bezpo
na lub w bezpo
ś
ś
rednim s
rednim s
ą
ą
siedztwie
siedztwie
(zazwyczaj grzanego) pod
(zazwyczaj grzanego) pod
ł
ł
o
o
ż
ż
a).
a).

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Techniki CVD
Techniki CVD
–
–
niekt
niekt
ó
ó
re
re
uwarunkowania krytyczne
uwarunkowania krytyczne
(spos
(spos
ó
ó
b aktywacji proces
b aktywacji proces
ó
ó
w, dob
w, dob
ó
ó
r temperatury)
r temperatury)
Monokrystaliczno
Monokrystaliczno
ść
ść
warstw
warstw
Ö
Ö
proces heterogeniczny
proces heterogeniczny
Ø
Ø
Plazma ? NIE !!! (bo zarodkowanie w obj
Plazma ? NIE !!! (bo zarodkowanie w obj
ę
ę
to
to
ś
ś
ci)
ci)
Ø
Ø
czyli: g
czyli: g
ł
ł
ó
ó
wnie aktywacja termiczna !
wnie aktywacja termiczna !
T
T
pod
pod
ł
ł
o
o
ż
ż
a
a
>>
>>
T
T
gazu
gazu
? NIE !!! (pod
? NIE !!! (pod
ł
ł
o
o
ż
ż
e promieniuje ciep
e promieniuje ciep
ł
ł
o i
o i
T
T
gazu
gazu
Ê
Ê
)
)
Ø
Ø
zn
zn
ó
ó
w procesy homogeniczne
w procesy homogeniczne

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Techniki PVD
Techniki PVD
Proces syntezy materia
Proces syntezy materia
ł
ł
u bez udzia
u bez udzia
ł
ł
u reakcji
u reakcji
chemicznych, w wyniku kondensacji tworz
chemicznych, w wyniku kondensacji tworz
ą
ą
cych
cych
go atom
go atom
ó
ó
w z fazy lotnej. S
w z fazy lotnej. S
ą
ą
one uwalniane ze
one uwalniane ze
ź
ź
r
r
ó
ó
d
d
ł
ł
a/
a/
ź
ź
r
r
ó
ó
de
de
ł
ł
termicznie (grzanie, ablacja wi
termicznie (grzanie, ablacja wi
ą
ą
zk
zk
ą
ą
laserow
laserow
ą
ą
) b
) b
ą
ą
d
d
ź
ź
wskutek bombardowania wysoko
wskutek bombardowania wysoko
-
-
energetycznymi cz
energetycznymi cz
ą
ą
stkami, a nast
stkami, a nast
ę
ę
pnie
pnie
transporto
transporto
-
-
wane
wane
poprzez obszar
poprzez obszar
o obni
o obni
ż
ż
onym ci
onym ci
ś
ś
nieniu
nieniu
do
do
pod
pod
ł
ł
o
o
ż
ż
a, na kt
a, na kt
ó
ó
rym ulegaj
rym ulegaj
ą
ą
adsorpcji (najpierw
adsorpcji (najpierw
fizysorpcji
fizysorpcji
, a potem chemisorpcji).
, a potem chemisorpcji).

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Techniki PVD
Techniki PVD
–
–
niekt
niekt
ó
ó
re
re
uwarunkowania krytyczne
uwarunkowania krytyczne
D
D
ł
ł
ugo
ugo
ść
ść
drogi swobodnej
drogi swobodnej
λ
λ
≥
≥
wymiar
wymiar
ó
ó
w aparatury
w aparatury
Ø
Ø
Odpowiednio niskie ci
Odpowiednio niskie ci
ś
ś
nienia
nienia
p
p
!!!
!!!
cm
Pa
0,66
[
]
[
]
p
λ
≅
(dla powietrza)
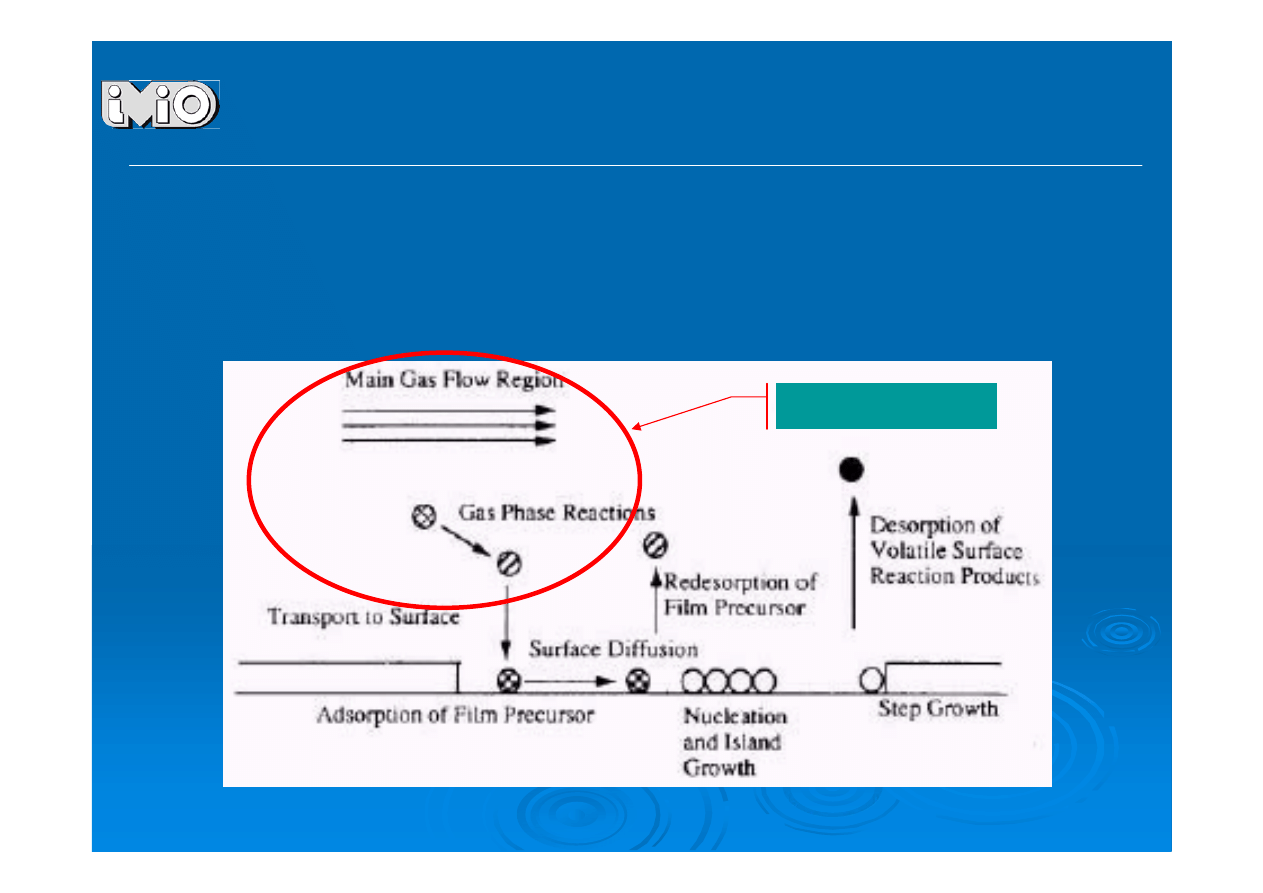
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Dynamika procesu epitaksji
Dynamika procesu epitaksji
Dotyczy CVD

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Czynniki kontroluj
Czynniki kontroluj
ą
ą
ce proces
ce proces
wzrostu warstw z fazy gazowej
wzrostu warstw z fazy gazowej
A
A
–
–
wzrost kontrolowany przez
wzrost kontrolowany przez
kinetyk
kinetyk
ę
ę
proces
proces
ó
ó
w powierzchniowych
w powierzchniowych
B
B
–
–
wzrost kontrolowany przez
wzrost kontrolowany przez
transport masy
transport masy
C
C
–
–
wzrost kontrolowany przez efekty
wzrost kontrolowany przez efekty
wysokotemp
wysokotemp
. (wi
. (wi
ę
ę
ksza desorpcja,
ksza desorpcja,
konkurencyjne reakcje chemiczne, jak
konkurencyjne reakcje chemiczne, jak
np. trawienie warstwy przez uboczne
np. trawienie warstwy przez uboczne
produkty reakcji, np.:
produkty reakcji, np.:
SiCl
SiCl
4
4
(g) + 2H
(g) + 2H
2
2
(g)
(g)
→
→
Si(s
Si(s
) + 4
) + 4
HCl
HCl
(g),
(g),
ale opr
ale opr
ó
ó
cz tego:
cz tego:
SiCl
SiCl
4
4
(g) +
(g) +
Si(s
Si(s
)
)
→
→
2SiCl
2SiCl
2
2
(
(
g
g
)
)
C
Epitaksja Si
Epitaksja Si
S.M. Sze, „Semiconductor devices…”, John Wiley & Sons, 1985

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
faza pocz
faza pocz
ą
ą
tkowa
tkowa
/
pow
epi
pow int
γ
γ
γ
+
<
/
pow
epi
pow int
γ
γ
γ
+
≈
/
pow
epi
pow int
γ
γ
γ
+
>
gdzie
gdzie
γ
γ
-
-
„
„
napr
napr
ęż
ęż
enia
enia
”
”
(a precyzyjniej
(a precyzyjniej
swobodne energie na jednostk
swobodne energie na jednostk
ę
ę
powierzchni
powierzchni
)
)
odpowiednio: powierzchni pod
odpowiednio: powierzchni pod
ł
ł
o
o
ż
ż
a, warstwy przej
a, warstwy przej
ś
ś
ciowej i epitaksjalnej
ciowej i epitaksjalnej

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
faza
faza
pocz
pocz
ą
ą
tkowa
tkowa
D
D
ąż
ąż
enie uk
enie uk
ł
ł
adu do najkorzystniejszego energetycznie stanu, czyli
adu do najkorzystniejszego energetycznie stanu, czyli
stanu o najni
stanu o najni
ż
ż
szej energii
szej energii
Niedopasowanie = napr
Niedopasowanie = napr
ęż
ęż
enie
enie
⇓
⇓
Uk
Uk
ł
ł
ad d
ad d
ąż
ąż
y do relaksacji (odpr
y do relaksacji (odpr
ęż
ęż
enia)
enia)
¾
¾
Pocz
Pocz
ą
ą
tkowo mo
tkowo mo
ż
ż
e si
e si
ę
ę
to odbywa
to odbywa
ć
ć
bez powstawania dyslokacji
bez powstawania dyslokacji
(
(
deformacja spr
deformacja spr
ęż
ęż
ysta
ysta
)
)
¾
¾
Powy
Powy
ż
ż
ej pewnych rozmiar
ej pewnych rozmiar
ó
ó
w wyspy odpr
w wyspy odpr
ęż
ęż
enie mo
enie mo
ż
ż
liwe tylko
liwe tylko
poprzez
poprzez
deformacj
deformacj
ę
ę
plastyczn
plastyczn
ą
ą
, a wi
, a wi
ę
ę
c powstanie dyslokacji
c powstanie dyslokacji
nieodwracalna !
nieodwracalna !
odwracalna !
odwracalna !

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
faza
faza
pocz
pocz
ą
ą
tkowa
tkowa
Rodzaj wzrostu okre
Rodzaj wzrostu okre
ś
ś
lony jest stopniem niedopasowania
lony jest stopniem niedopasowania
ε
ε
sta
sta
ł
ł
ych sieci pod
ych sieci pod
ł
ł
o
o
ż
ż
a
a
a
a
pod
pod
ł
ł
i warstwy
i warstwy
a
a
epi
epi
, gdzie:
, gdzie:
ε
ε
< 0 (czyli
< 0 (czyli
a
a
pod
pod
ł
ł
<
<
a
a
epi
epi
)
)
⇒
⇒
n
n
apr
apr
ęż
ęż
enia
enia
ś
ś
ciskaj
ciskaj
ą
ą
ce (i ekspansja
ce (i ekspansja
narastaj
narastaj
ą
ą
cej warstwy w kierunku wzrostu)
cej warstwy w kierunku wzrostu)
ε
ε
> 0 (czyli
> 0 (czyli
a
a
pod
pod
ł
ł
>
>
a
a
epi
epi
)
)
⇒
⇒
n
n
apr
apr
ęż
ęż
enia rozci
enia rozci
ą
ą
gaj
gaj
ą
ą
ce (i kurczenie
ce (i kurczenie
si
si
ę
ę
narastaj
narastaj
ą
ą
cej warstwy w kierunku wzrostu)
cej warstwy w kierunku wzrostu)
ł
−
=
pod
epi
epi
a
a
a
ε

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
faza pocz
faza pocz
ą
ą
tkowa
tkowa
a)
a)
Wzrost
Wzrost
Franka
Franka
-
-
Van
Van
der
der
Merve
Merve
’
’
a
a
–
–
praktycznie tylko w
praktycznie tylko w
przy
przy
-
-
padku
padku
homoepitaksji
homoepitaksji
(ew. dla
(ew. dla
⏐
⏐
ε
ε
⏐
⏐
< 2%)
< 2%)
np
np
.: Si na Si czy
.: Si na Si czy
AlAs
AlAs
na
na
GaAs
GaAs
b)
b)
Wzrost typu
Wzrost typu
Stranskiego
Stranskiego
-
-
Krastanowa
Krastanowa
–
–
dla 2% <
dla 2% <
⏐
⏐
ε
ε
⏐
⏐
< 10%
< 10%
(a nawet 14% przy ni
(a nawet 14% przy ni
ż
ż
szych temperaturach procesu, ale wtedy
szych temperaturach procesu, ale wtedy
warstwa metastabilna)
warstwa metastabilna)
np
np
.: Ge na Si,
.: Ge na Si,
InAs
InAs
na
na
GaAs
GaAs
(
(
max
max
. grubo
. grubo
ść
ść
warstwy
warstwy
„
„
zwil
zwil
ż
ż
aj
aj
ą
ą
cej
cej
”
”
kilka ML, bo
kilka ML, bo
energia zwi
energia zwi
ą
ą
zana z napr
zana z napr
ęż
ęż
eniem jest ~ grubo
eniem jest ~ grubo
ś
ś
ci warstwy)
ci warstwy)
c)
c)
Wzrost typu
Wzrost typu
Volmera
Volmera
-
-
Webera
Webera
–
–
dla
dla
⏐
⏐
ε
ε
⏐
⏐
> 10%
> 10%

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
powstawanie wysp
powstawanie wysp
–
–
zaleta czy wada?
zaleta czy wada?
P. Finnie and Y. Homma, Surf. Sci. 500 (2002) 437
Wytwarzanie warstw grubszych
Wytwarzanie warstw grubszych
–
–
mniejsza g
mniejsza g
ł
ł
adko
adko
ść
ść
powierzchni
powierzchni
Czasy procesu: a) 5,1 min; b) 13 min;
c) 20 min; d) 45 min;
e) 97 min; f) 169 min

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
powstawanie
powstawanie
wysp
wysp
–
–
zaleta czy wada?
zaleta czy wada?
Mo
Mo
ż
ż
liwo
liwo
ść
ść
wytwarzania
wytwarzania
samoorganizuj
samoorganizuj
ą
ą
cych si
cych si
ę
ę
kropek kwantowych
kropek kwantowych
(
(
przy odpowiednio wczesnym
przy odpowiednio wczesnym
przerwaniu procesu s
przerwaniu procesu s
ą
ą
to
to
obiekty
obiekty
bezdyslokacyjne
bezdyslokacyjne
!
!
)
)
Ale:
Ale:
na razie wci
na razie wci
ąż
ąż
mamy k
mamy k
ł
ł
opoty z
opoty z
kontrol
kontrol
ą
ą
ich lokalizacji
ich lokalizacji
P. Finnie and Y. Homma, Surf. Sci. 500 (2002) 437

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
wybrane
wybrane
zagadnienia
zagadnienia
Pozorna migracja wysp
Pozorna migracja wysp
–
–
przeskakiwanie
przeskakiwanie
adatom
adatom
ó
ó
w
w
(przypadek wyspy 1
(przypadek wyspy 1
-
-
wymiarowej)
wymiarowej)
P. Finnie and Y. Homma, Surf. Sci. 500 (2002) 437

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny
Wzrost epitaksjalny
–
–
wybrane zagadnienia
wybrane zagadnienia
P. Finnie and Y. Homma, Surf. Sci. 500 (2002) 437
Ewolucja rozmiar
Ewolucja rozmiar
ó
ó
w wysp w czasie
w wysp w czasie
(
r
r
zar
zar
>
>
r
r
kryt
kryt
⇒
⇒
r
r
zar
zar
Ê
Ê
⇒
⇒
ca
ca
ł
ł
kowita energia swobodna uk
kowita energia swobodna uk
ł
ł
adu
adu
Ì
Ì
)
)
r
r
zar
zar
<
<
r
r
kryt
kryt
⇒
⇒
A
A
zar
zar
/
/
V
V
zar
zar
↑
↑
; w
; w
ó
ó
wczas
wczas
r
r
zar
zar
Ê
Ê
⇒
⇒
ca
ca
ł
ł
kowita energia swobodna uk
kowita energia swobodna uk
ł
ł
adu
adu
Ê
Ê
(uk
(uk
ł
ł
ad mo
ad mo
ż
ż
e obni
e obni
ż
ż
y
y
ć
ć
ca
ca
ł
ł
k
k
. energi
. energi
ę
ę
swobodn
swobodn
ą
ą
poprzez redukcj
poprzez redukcj
ę
ę
rozmiar
rozmiar
ó
ó
w;
w;
r
r
zar
zar
>
>
r
r
kryt
kryt
⇒
⇒
uk
uk
ł
ł
ad mo
ad mo
ż
ż
e
e
obni
obni
ż
ż
y
y
ć
ć
ca
ca
ł
ł
kowit
kowit
ą
ą
energi
energi
ę
ę
swobodn
swobodn
ą
ą
poprzez wzrost)
poprzez wzrost)
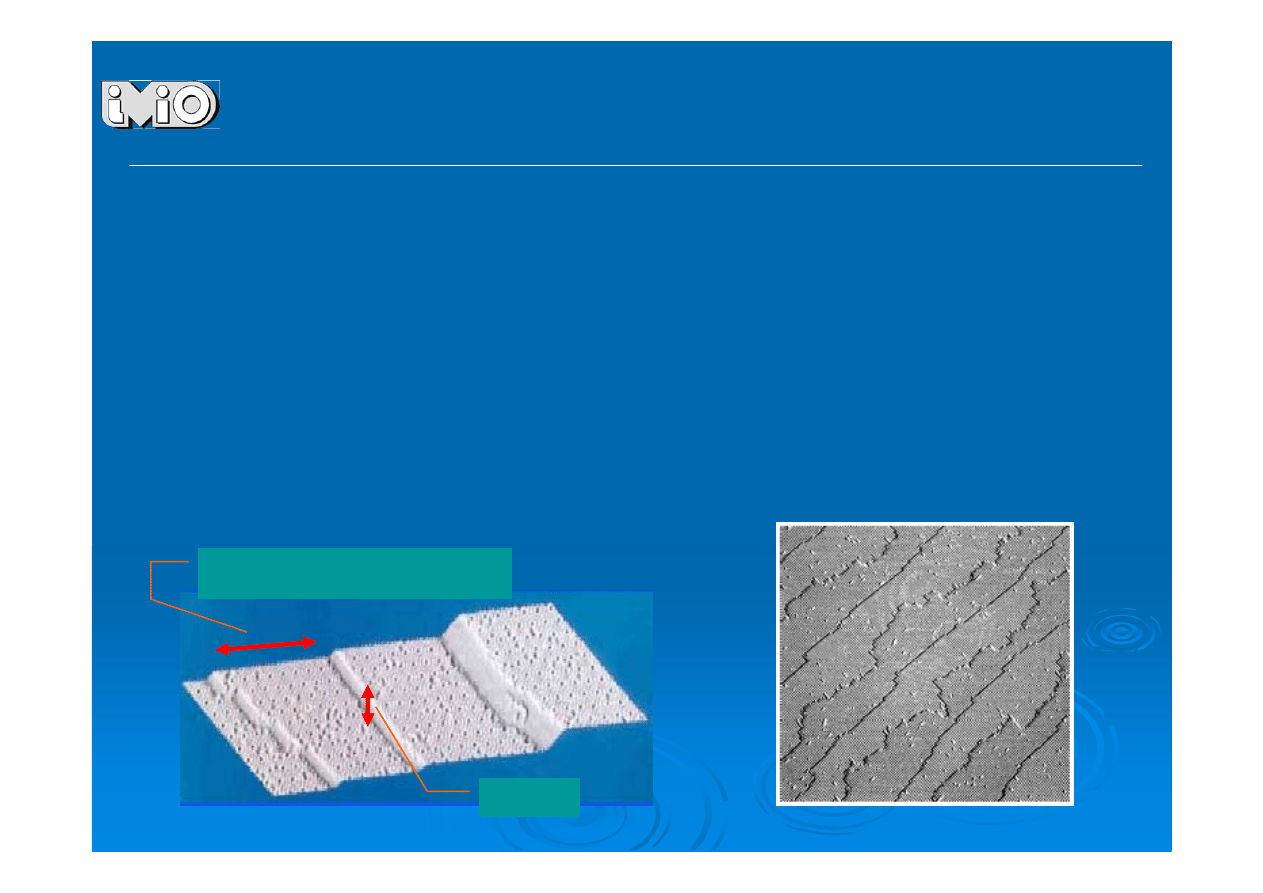
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny na powierzchniach
Wzrost epitaksjalny na powierzchniach
wicynalnych
wicynalnych
J.R. Arthur, Surf.Sci. 500 (2002) 189
Powierzchnia
Powierzchnia
wicynalna
wicynalna
–
–
powierzchnia tarasowa powsta
powierzchnia tarasowa powsta
ł
ł
a wskutek
a wskutek
ci
ci
ę
ę
cia lub polerowania pod
cia lub polerowania pod
ł
ł
o
o
ż
ż
a pod k
a pod k
ą
ą
tem nieco innym (dziesi
tem nieco innym (dziesi
ą
ą
te
te
cz
cz
ęś
ęś
ci stopnia) do p
ci stopnia) do p
ł
ł
aszczyzny krystalograficznej
aszczyzny krystalograficznej
–
–
praktycznie ka
praktycznie ka
ż
ż
da
da
powierzchnia
powierzchnia
10 nm…kilka
μm
1 ML
Najlepsze komercyjnie dost
Najlepsze komercyjnie dost
ę
ę
pne pod
pne pod
ł
ł
o
o
ż
ż
a:
a:

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost epitaksjalny na powierzchniach
Wzrost epitaksjalny na powierzchniach
wicynalnych
wicynalnych
Najkorzystniejsze energetycznie
Najkorzystniejsze energetycznie
miejsca wbudowywania si
miejsca wbudowywania si
ę
ę
adatom
adatom
ó
ó
w
w
Celowe wprowadzanie
Celowe wprowadzanie
wicynalno
wicynalno
ś
ś
ci
ci
, bo
, bo
•
proces bardziej efektywny
proces bardziej efektywny
•
•
lepsza jako
lepsza jako
ść
ść
warstw
warstw
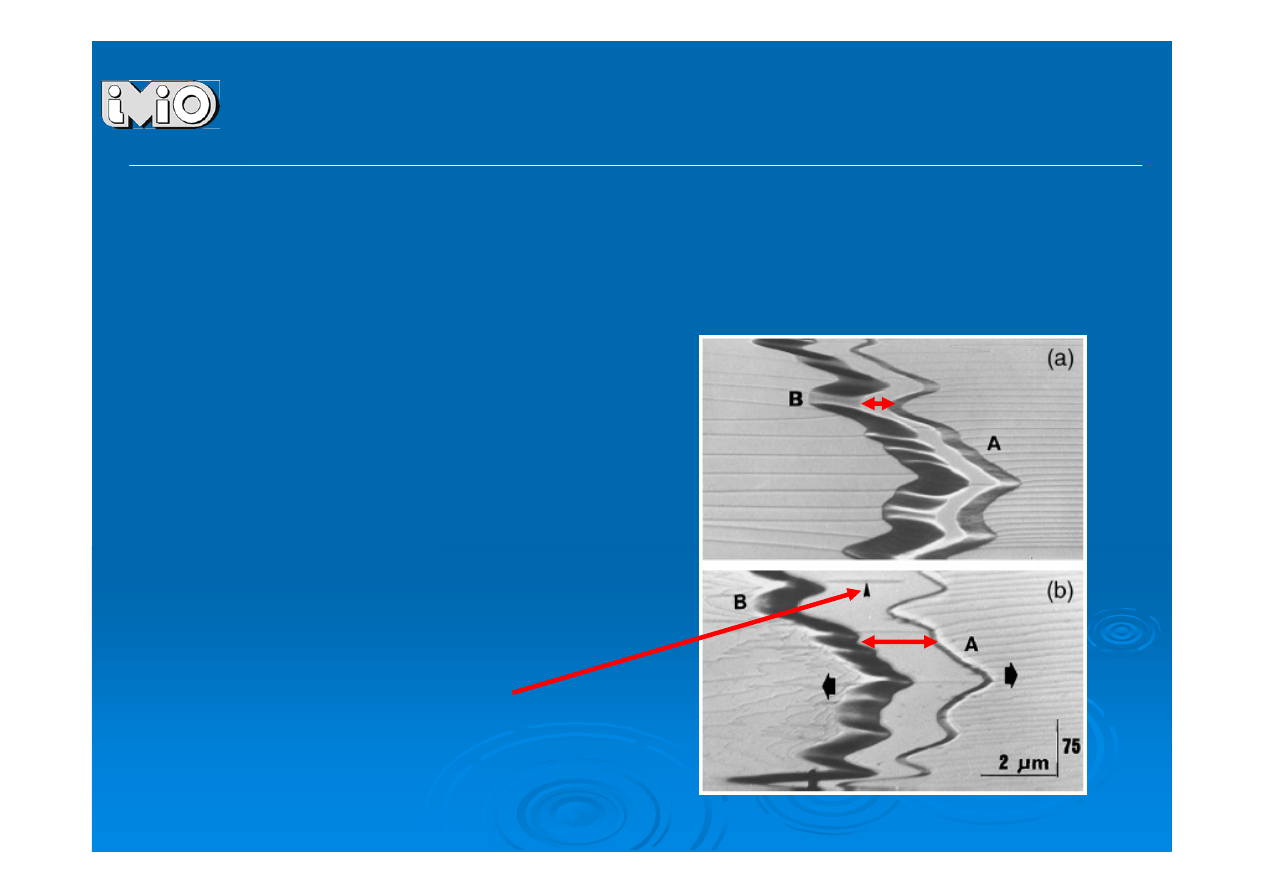
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost warstwy typu
Wzrost warstwy typu
„
„
step
step
flow
flow
”
”
P. Finnie and Y. Homma, Surf. Sci. 500 (2002) 437
w
w
ą
ą
ski grzbiet:
ski grzbiet:
droga migracji >
droga migracji >
d
d
Ø
Ø
brak
brak
nukleacji
nukleacji
wysp
wysp
Ø
Ø
step
step
flow
flow
d
Ø
Ø
szerszy grzbiet:
szerszy grzbiet:
droga migracji <
droga migracji <
d
d
Ø
Ø
nukleacja
nukleacja
wysp
wysp
d
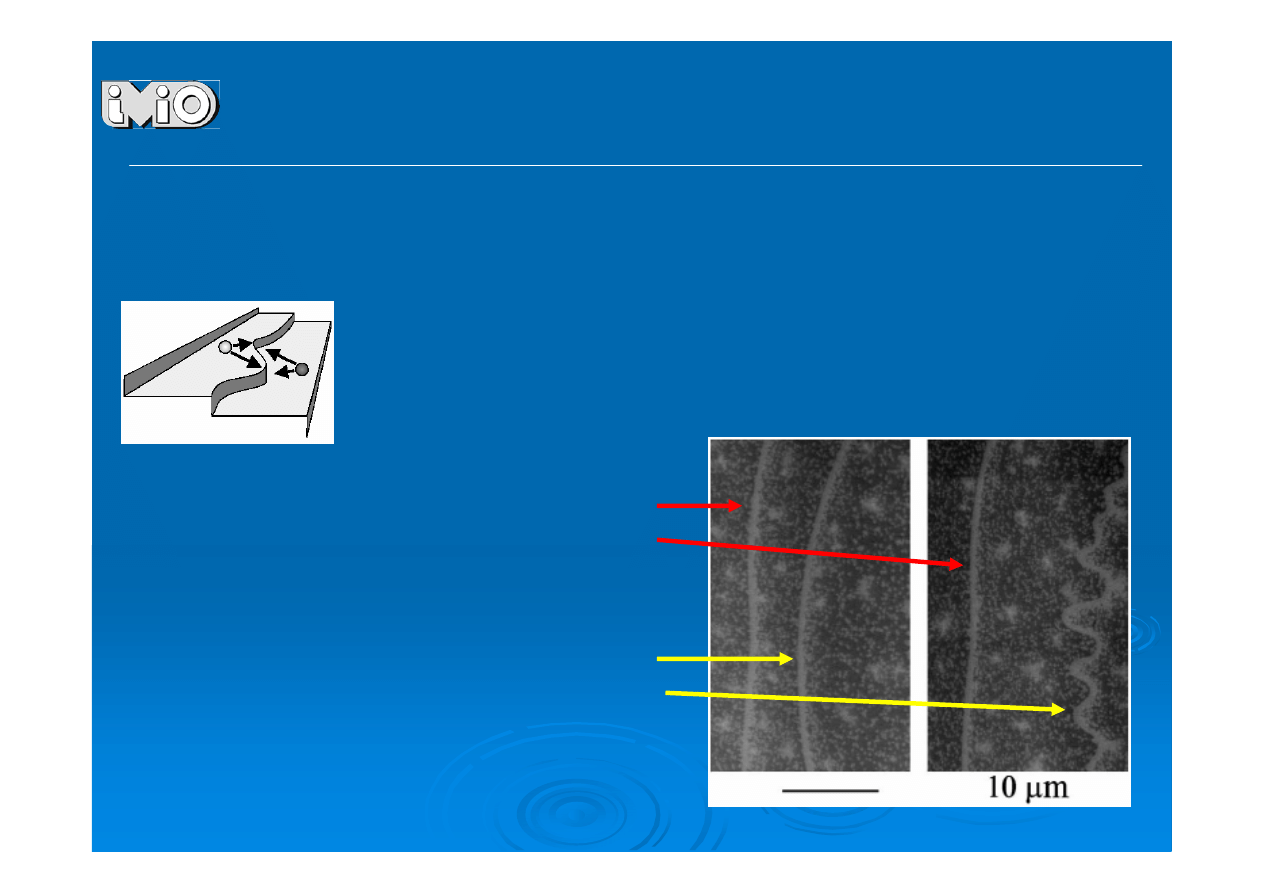
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Wzrost warstwy typu
Wzrost warstwy typu
„
„
step
step
flow
flow
”
”
–
–
niestabilno
niestabilno
ść
ść
progu
progu
w
w
ęż
ęż
szy taras
szy taras
Ö
Ö
mniej adsorbowanych
mniej adsorbowanych
atom
atom
ó
ó
w / jednostk
w / jednostk
ę
ę
czasu
czasu
Ö
Ö
wolniejszy
wolniejszy
i bardziej stabilny rozrost progu
i bardziej stabilny rozrost progu
P. Finnie and Y. Homma, Surf. Sci. 500 (2002) 437
szerszy taras
szerszy taras
Ö
Ö
wi
wi
ę
ę
cej adsorbowanych
cej adsorbowanych
atom
atom
ó
ó
w / jednostk
w / jednostk
ę
ę
czasu
czasu
Ö
Ö
szybszy
szybszy
i mniej stabilny rozrost progu
i mniej stabilny rozrost progu

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Przyk
Przyk
ł
ł
ady proces
ady proces
ó
ó
w wytwarzania
w wytwarzania
ultracienkich
ultracienkich
warstw
warstw
¾
¾
MBE (
MBE (
Molecular
Molecular
Beam
Beam
Epitaxy
Epitaxy
),
),
¾
¾
MOMBE (
MOMBE (
Metalorganic
Metalorganic
MBE),
MBE),
¾
¾
CBE (
CBE (
Chemical
Chemical
Beam
Beam
Epitaxy
Epitaxy
),
),
¾
¾
MEE (
MEE (
Migration
Migration
Enhanced
Enhanced
Epitaxy
Epitaxy
),
),
¾
¾
PLE (
PLE (
Phase
Phase
-
-
Locked
Locked
Epitaxy
Epitaxy
),
),
¾
¾
MOCVD (
MOCVD (
Metalorganic
Metalorganic
CVD), OMCVD (
CVD), OMCVD (
Organometallic
Organometallic
CVD),
CVD),
¾
¾
ALE (
ALE (
Atomic
Atomic
Layer
Layer
Epitaxy
Epitaxy
),
),
¾
¾
……………
……………

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
Proces krystalizacji warstw z wi
Proces krystalizacji warstw z wi
ą
ą
zek
zek
molekularnych (lub atomowych), padaj
molekularnych (lub atomowych), padaj
ą
ą
cych
cych
w
w
ultrawysokiej
ultrawysokiej
pr
pr
ó
ó
ż
ż
ni (
ni (
p
p
≤
≤
10
10
-
-
7
7
Pa)
Pa)
na
na
podgrzewane pod
podgrzewane pod
ł
ł
o
o
ż
ż
e.
e.

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
czysto
czysto
ść
ść
!
!
Czas pokrycia powierzchni przez
Czas pokrycia powierzchni przez
monowarstw
monowarstw
ę
ę
O
O
2
2
:
:
p
p
= 10
= 10
2
2
Pa
Pa
Ö
Ö
t
t
≅
≅
2
2
μ
μ
s
s
,
,
p
p
= 10
= 10
-
-
8
8
Pa
Pa
Ö
Ö
t
t
≅
≅
2 s
2 s
,
,
p
p
= 10
= 10
-
-
12
12
Pa
Pa
Ö
Ö
t
t
≅
≅
6 h
6 h
,
,
-2 -1
cm s
2
⎡
⎤
=
⎣
⎦
dn
p
dt
mkT
π
gdzie:
gdzie:
p
p
–
–
ci
ci
ś
ś
nienie,
nienie,
m
m
–
–
masa atomowa gazu
masa atomowa gazu
Liczba atom
Liczba atom
ó
ó
w
w
n
n
przybywaj
przybywaj
ą
ą
cych na jednostk
cych na jednostk
ę
ę
powierzchni w ci
powierzchni w ci
ą
ą
gu sekundy:
gu sekundy:

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
-
-
procesy kinetyczne na
procesy kinetyczne na
pod
pod
ł
ł
o
o
ż
ż
u podczas wzrostu warstwy
u podczas wzrostu warstwy
M.A. Herman, w: „VLSI kierunki,…”, A. Jakubowski (ed.), PWN, Warszawa, 1988

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
-
-
procesy kinetyczne na pod
procesy kinetyczne na pod
ł
ł
o
o
ż
ż
u
u
podczas wzrostu warstwy
podczas wzrostu warstwy
M.A. Herman, w: „VLSI kierunki,…”, A. Jakubowski (ed.), PWN, Warszawa, 1988
Ga
Ga

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
komora wzrostu warstwy
komora wzrostu warstwy
J.R. Arthur, Surf.Sci. 500 (2002) 189

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
J.R. Arthur, Surf.Sci. 500 (2002) 189
często
dodatkowa
możliwość
grzania podłoży
w celu
odgazowania
spotykana dodatkowa komora umożliwiająca
wytwarzanie warstw z innych pierwiastków (np. AIIIBV
vs. AIIBVI)

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
kom
kom
ó
ó
rki efuzyjne
rki efuzyjne
J.R. Arthur, Surf.Sci. 500 (2002) 189

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
wybrane zagadnienia
wybrane zagadnienia
konstrukcyjno
konstrukcyjno
-
-
technologiczne
technologiczne
Kom
Kom
ó
ó
rki efuzyjne:
rki efuzyjne:
¾
¾
odpowiedni dob
odpowiedni dob
ó
ó
r materia
r materia
ł
ł
ó
ó
w
w
¾
¾
kontrola temperatury
kontrola temperatury
-
-
Δ
Δ
T
T
= 1
= 1
o
o
C
C
Ö
Ö
Δ
Δ
I
I
wi
wi
ą
ą
zki
zki
= 2% !
= 2% !
Ø
Ø
-
-
korpus
korpus
:
:
P
P
-
-
BN
BN
-
-
os
os
ł
ł
ony
ony
: folie Ta
: folie Ta
-
-
termopara
termopara
: stop W/Re
: stop W/Re

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
wybrane zagadnienia
wybrane zagadnienia
konstrukcyjno
konstrukcyjno
-
-
technologiczne
technologiczne
Kom
Kom
ó
ó
rki efuzyjne:
rki efuzyjne:
¾
¾
geometria
geometria
-
-
sto
sto
ż
ż
kowa
kowa
-
-
bardziej stabilny rozk
bardziej stabilny rozk
ł
ł
ad k
ad k
ą
ą
towy wi
towy wi
ą
ą
zki w miar
zki w miar
ę
ę
zu
zu
ż
ż
ywania wsadu,
ywania wsadu,
-
-
redukuje
redukuje
„
„
samoogniskowanie
samoogniskowanie
”
”
si
si
ę
ę
wi
wi
ą
ą
zki
zki
-
-
odleg
odleg
ł
ł
o
o
ść
ść
ź
ź
r
r
ó
ó
d
d
ł
ł
o
o
-
-
pod
pod
ł
ł
o
o
ż
ż
e
e
r
r
oraz rozmiary k
oraz rozmiary k
ą
ą
towe i orientacja pod
towe i orientacja pod
ł
ł
o
o
ż
ż
a:
a:
I
I
wi
wi
ą
ą
zki
zki
~ 1/
~ 1/
r
r
:
:
r
r
Ê
Ê
Ö
Ö
I
I
wi
wi
ą
ą
zki
zki
Ì
Ì
I
I
wi
wi
ą
ą
zki
zki
~ cos
~ cos
3
3
θ
θ
:
:
r
r
Ê
Ê
Ö
Ö
I
I
wi
wi
ą
ą
zki
zki
ÌÌ
ÌÌ
Ø
Ø
ma
ma
ł
ł
e pod
e pod
ł
ł
o
o
ż
ż
a lub
a lub
r
r
↑
↑

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
kom
kom
ó
ó
rki efuzyjne modu
rki efuzyjne modu
ł
ł
owe
owe
J.R. Arthur, Surf.Sci. 500 (2002) 189
-
-
wytwarzanie wi
wytwarzanie wi
ą
ą
zek z
zek z
materia
materia
ł
ł
ó
ó
w o du
w o du
ż
ż
ej
ej
pr
pr
ęż
ęż
no
no
ś
ś
ci par (np. As),
ci par (np. As),
-
-
wytwarzanie wi
wytwarzanie wi
ą
ą
zek
zek
gdy potrzebny jest
gdy potrzebny jest
nadmiar koncentracji
nadmiar koncentracji
danego zwi
danego zwi
ą
ą
zku
zku

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
kom
kom
ó
ó
rki efuzyjne modu
rki efuzyjne modu
ł
ł
owe
owe
Kom
Kom
ó
ó
rki 2
rki 2
-
-
modu
modu
ł
ł
owe
owe
:
:
¾
¾
modu
modu
ł
ł
z wsadem
z wsadem
–
–
na zewn
na zewn
ą
ą
trz uk
trz uk
ł
ł
adu pr
adu pr
ó
ó
ż
ż
niowego (bo
niowego (bo
konieczno
konieczno
ść
ść
cz
cz
ę
ę
stego uzupe
stego uzupe
ł
ł
niania zawarto
niania zawarto
ś
ś
ci),
ci),
¾
¾
modu
modu
ł
ł
z dysz
z dysz
ą
ą
–
–
w obszarze pr
w obszarze pr
ó
ó
ż
ż
ni
ni
(cz
(cz
ę
ę
sto zawiera grzejnik, tzw.
sto zawiera grzejnik, tzw.
„
„
kraker
kraker
”
”
(np. drut W) czyli
(np. drut W) czyli
uk
uk
ł
ł
ad do rozk
ad do rozk
ł
ł
adu temperaturowego cz
adu temperaturowego cz
ą
ą
stek bardziej
stek bardziej
z
z
ł
ł
o
o
ż
ż
onych na prostsze, np.
onych na prostsze, np.
tetramer
tetramer
ó
ó
w
w
(As
(As
4
4
) na dimery
) na dimery
(As
(As
2
2
))
))

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
-
-
przes
przes
ł
ł
ony
ony
¾
¾
odpowiedni dob
odpowiedni dob
ó
ó
r materia
r materia
ł
ł
u,
u,
¾
¾
odpowiednia odleg
odpowiednia odleg
ł
ł
o
o
ść
ść
od wylotu kom
od wylotu kom
ó
ó
rki
rki
efuzyjnej
efuzyjnej
¾
¾
u
u
ł
ł
o
o
ż
ż
enie pod odpowiednim k
enie pod odpowiednim k
ą
ą
tem
tem

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
monta
monta
ż
ż
p
p
ł
ł
ytek pod
ytek pod
ł
ł
o
o
ż
ż
owych
owych
Cel: uzyskanie dobrego kontaktu termicznego pod
Cel: uzyskanie dobrego kontaktu termicznego pod
ł
ł
o
o
ż
ż
e
e
-
-
grzejnik
grzejnik
¾
¾
Kontakt In
Kontakt In
zalety:
zalety:
-
-
dobre sprz
dobre sprz
ęż
ęż
enie cieplne pod
enie cieplne pod
ł
ł
o
o
ż
ż
e
e
-
-
grzejnik,
grzejnik,
-
-
ciek
ciek
ł
ł
y
y
,
,
-
-
niska pr
niska pr
ęż
ęż
no
no
ść
ść
par dla
par dla
T
T
< 600
< 600
o
o
C
C
wady:
wady:
-
-
wzrost pr
wzrost pr
ęż
ęż
no
no
ś
ś
ci par dla
ci par dla
T
T
> 600
> 600
o
o
C
C
-
-
konieczno
konieczno
ść
ść
czyszczenia spodu pod
czyszczenia spodu pod
ł
ł
o
o
ż
ż
y z In po procesie
y z In po procesie
epitaksji
epitaksji
¾
¾
mocowania i grzejniki o specjalnej geometrii z przek
mocowania i grzejniki o specjalnej geometrii z przek
ł
ł
adkami BN
adkami BN

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
pomiar temperatury pod
pomiar temperatury pod
ł
ł
o
o
ż
ż
y
y
¾
¾
termopary
termopary
¾
¾
pirometry optyczne IR
pirometry optyczne IR

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
r
r
ó
ó
wnomierny rozk
wnomierny rozk
ł
ł
ad wi
ad wi
ą
ą
zki
zki
¾
¾
Rotacja panelu z pod
Rotacja panelu z pod
ł
ł
o
o
ż
ż
ami
ami
J.R. Arthur, Surf.Sci. 500 (2002) 189

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
kontrola procesu epitaksji
kontrola procesu epitaksji
Przede wszystkim
Przede wszystkim
RHEED
RHEED
(
(
Reflection
Reflection
High
High
-
-
Energy
Energy
Electron
Electron
Diffraction
Diffraction
)
)
pomiar
pomiar
in
in
situ
situ
!!!
!!!
-
-
monitorowanie tempa wzrostu warstwy,
monitorowanie tempa wzrostu warstwy,
-
-
badanie morfologii powierzchni,
badanie morfologii powierzchni,
-
-
badanie struktury powierzchni (co w nie
badanie struktury powierzchni (co w nie
-
-
kt
kt
ó
ó
rych sytuacjach przek
rych sytuacjach przek
ł
ł
ada si
ada si
ę
ę
na informacj
na informacj
ę
ę
o jej sk
o jej sk
ł
ł
adzie chemicznym)
adzie chemicznym)
-
-
ze wzgl
ze wzgl
ę
ę
du na du
du na du
ż
ż
y k
y k
ą
ą
t padania wi
t padania wi
ą
ą
zki
zki
e
e
⎯
⎯
nie
nie
zak
zak
ł
ł
ó
ó
ca toru wi
ca toru wi
ą
ą
zek molekularnych
zek molekularnych
A.
Y. Cho,
J.Vac.Sci.Technol
.8
(1971)S31 (za: CT. Foxon,
J.Cry
st.Growth
251
(2003)1
)
ale: niewskazane d
ale: niewskazane d
ł
ł
u
u
ż
ż
sze na
sze na
ś
ś
wietlanie rosn
wietlanie rosn
ą
ą
cej warstwy
cej warstwy
(wysokoenergetyczne elektrony !!!)
(wysokoenergetyczne elektrony !!!)
Ö
Ö
stosowanie pod
stosowanie pod
ł
ł
o
o
ż
ż
y kontrolnych
y kontrolnych

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
kontrola procesu epitaksji
kontrola procesu epitaksji
Ponadto: LEED, AES, XPS,
Ponadto: LEED, AES, XPS,
dyfrakcja rentgenowska
dyfrakcja rentgenowska
…
…
Cz
Cz
ę
ę
sto wymaga to jednak
sto wymaga to jednak
odr
odr
ę
ę
bnej
bnej
„
„
analitycznej
analitycznej
”
”
komory
komory
pr
pr
ó
ó
ż
ż
niowej
niowej
J.R. Arthur, Surf.Sci. 500 (2002) 189
Korelacja pomiędzy stopniem pokrycia
powierzchni a intensywnością obrazu
RHEED
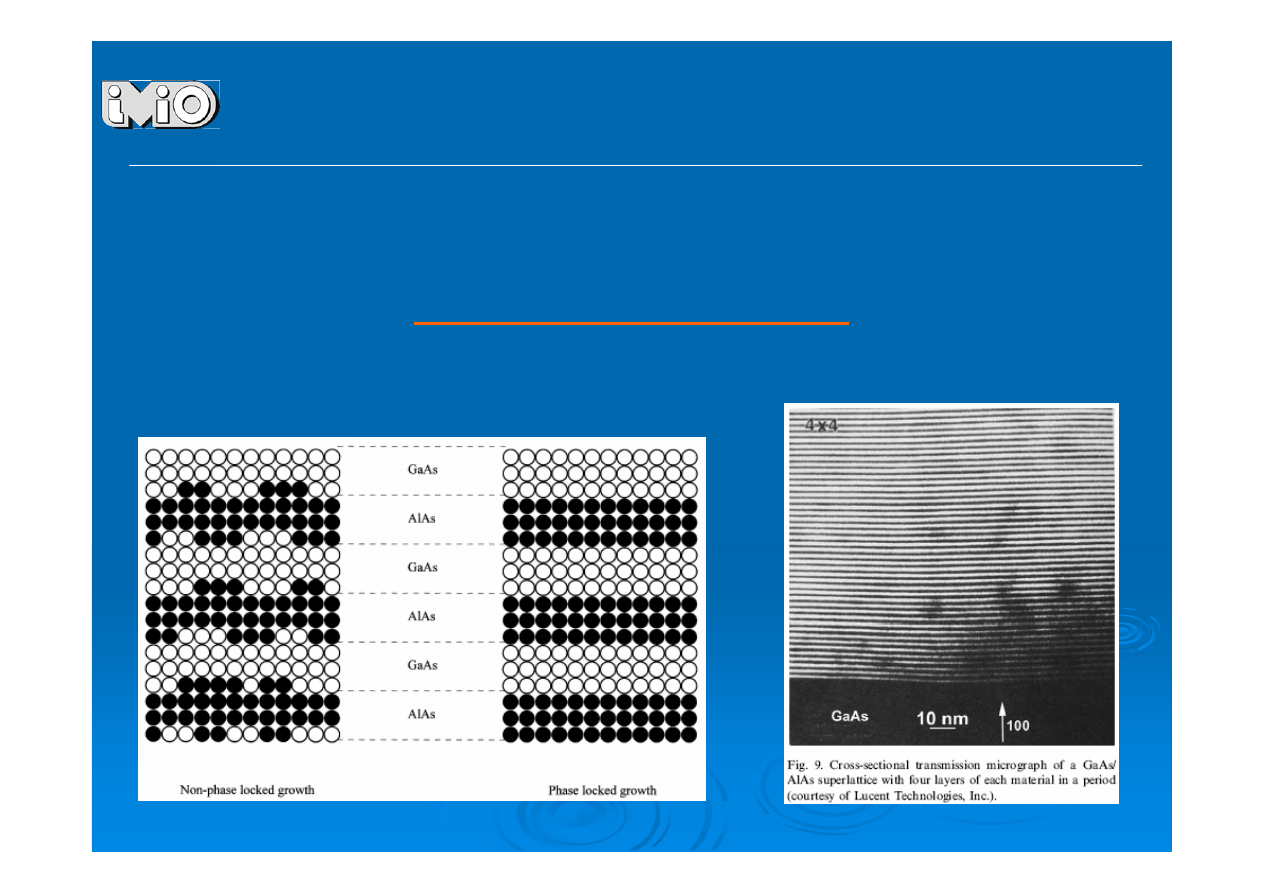
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
wybrane modyfikacje
wybrane modyfikacje
1. Phase-locked epitaxy (PLE):
J.R. Arthur, Surf.Sci. 500 (2002) 189

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MBE
MBE
–
–
wybrane modyfikacje
wybrane modyfikacje
2.
2.
Surfactant
Surfactant
Assisted
Assisted
Growth
Growth
(wzrost wspomagany zwi
(wzrost wspomagany zwi
ą
ą
zkami powierzchniowo czynnymi)
zkami powierzchniowo czynnymi)
Cel: minimalizacja
Cel: minimalizacja
T
T
pod
pod
ł
ł
o
o
ż
ż
a
a

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MO CVD
MO CVD
¾
¾
Wariant krystalizacji warstw z fazy gazowej
Wariant krystalizacji warstw z fazy gazowej
wykorzystuj
wykorzystuj
ą
ą
cy jako prekursory zwi
cy jako prekursory zwi
ą
ą
zki
zki
metalo
metalo
-
-
organiczne
organiczne
.
.
¾
¾
Synteza materia
Synteza materia
ł
ł
u (w postaci mono
u (w postaci mono
-
-
,
,
poli
poli
-
-
krystalicznej
krystalicznej
b
b
ą
ą
d
d
ź
ź
amorficznej) nast
amorficznej) nast
ę
ę
puje w wyniku
puje w wyniku
reakcji chemicznych pomi
reakcji chemicznych pomi
ę
ę
dzy lotnymi reagentami
dzy lotnymi reagentami
metaloorganicznymi zawieraj
metaloorganicznymi zawieraj
ą
ą
cymi sk
cymi sk
ł
ł
adniki
adniki
krystalizowanej warstwy.
krystalizowanej warstwy.

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MO CVD i OM CVD
MO CVD i OM CVD
Zwi
Zwi
ą
ą
zki metaloorganiczne
zki metaloorganiczne
: zasadniczo
: zasadniczo
zwi
zwi
ą
ą
zki zawieraj
zki zawieraj
ą
ą
ce
ce
atomy metalu przy
atomy metalu przy
łą
łą
czone do organicznych rodnik
czone do organicznych rodnik
ó
ó
w
w
, ale
, ale
zwyczajowo tak
zwyczajowo tak
ż
ż
e: wodorki, alkoholany, amidy,
e: wodorki, alkoholany, amidy,
tiole
tiole
,
,
fosforki
fosforki
…
…
Ø
Ø
MO CVD
MO CVD
Zwi
Zwi
ą
ą
zki
zki
organometaliczne
organometaliczne
: zwi
: zwi
ą
ą
zki, w kt
zki, w kt
ó
ó
rych atomy metalu s
rych atomy metalu s
ą
ą
bezpo
bezpo
ś
ś
rednio zwi
rednio zwi
ą
ą
zane z atomami w
zane z atomami w
ę
ę
gla
gla
Ø
Ø
OM CVD
OM CVD

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MO CVD
MO CVD
–
–
cechy
cechy
charakterystyczne procesu
charakterystyczne procesu
MFC
MFC
K. Kosiel, „Technologia niskociśnieniowej epitaksji…”, Rozprawa Doktorska, PW 2002
Mieszalnik
(opcjonalnie)

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
- diody tunelowe,
- diody Gunna,
- diody PIN,
- diody rezonansowo-tunelowe,
- diody Schottky’ego,
- tranzystory polowe (np.HEMT),
- tranzystory bipolarne (np.HBT),
- układy scalone,
- diody elektroluminescencyjne,
- lasery (
λ
do 1,03
μm),
- fotokatody,
- baterie słoneczne (o dużych
powierzchniach jednorodnego
materiału),
- detektory podczerwieni,
- …
K.L. Choy,
Prog
.Mater.Sci
. 48
(2003) 57

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Dlaczego MO CVD
Dlaczego MO CVD
(procesy pod obni
(procesy pod obni
ż
ż
onym ci
onym ci
ś
ś
nieniem)
nieniem)
¾
¾
redukcja prawdopodobie
redukcja prawdopodobie
ń
ń
stwa zderze
stwa zderze
ń
ń
skutecznych
skutecznych
mi
mi
ę
ę
dzy moleku
dzy moleku
ł
ł
ami reagent
ami reagent
ó
ó
w w trakcie ich transportu
w w trakcie ich transportu
do komory reakcyjnej,
do komory reakcyjnej,
¾
¾
ograniczenie zjawiska konwekcji
ograniczenie zjawiska konwekcji

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MO CVD
MO CVD
–
–
charakterystyka procesu
charakterystyka procesu
Procesy w warstwie granicznej i na
Procesy w warstwie granicznej i na
powierzchni:
powierzchni:
pyroliza
pyroliza
prekursor
prekursor
ó
ó
w
w
Ø
Ø
adsorpcja reagent
adsorpcja reagent
ó
ó
w na powierzchni
w na powierzchni
pod
pod
ł
ł
o
o
ż
ż
a
a
Ø
Ø
reakcje chemiczne prowadz
reakcje chemiczne prowadz
ą
ą
ce do
ce do
krystalizacji warstwy
krystalizacji warstwy
Ø
Ø
wzrost warstwy
wzrost warstwy
Ø
Ø
desorpcja zb
desorpcja zb
ę
ę
dnych produkt
dnych produkt
ó
ó
w reakcji
w reakcji
M.A. Tischler,
IBM J.Res.Dev
. 34
(1990)
828
Przy niższych ciśnieniach
epitaksja kontrolowana przez
kinetykę procesów powierzchniowych!

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MO CVD
MO CVD
–
–
charakterystyka procesu
charakterystyka procesu
M.A. Herman, w: „VLSI kierunki,…”, A. Jakubowski (ed.), PWN, Warszawa, 1988
Reaktor o geometrii
rurowej
grzanie: rezystancyjne,
prąd w.cz.,
lampy IR
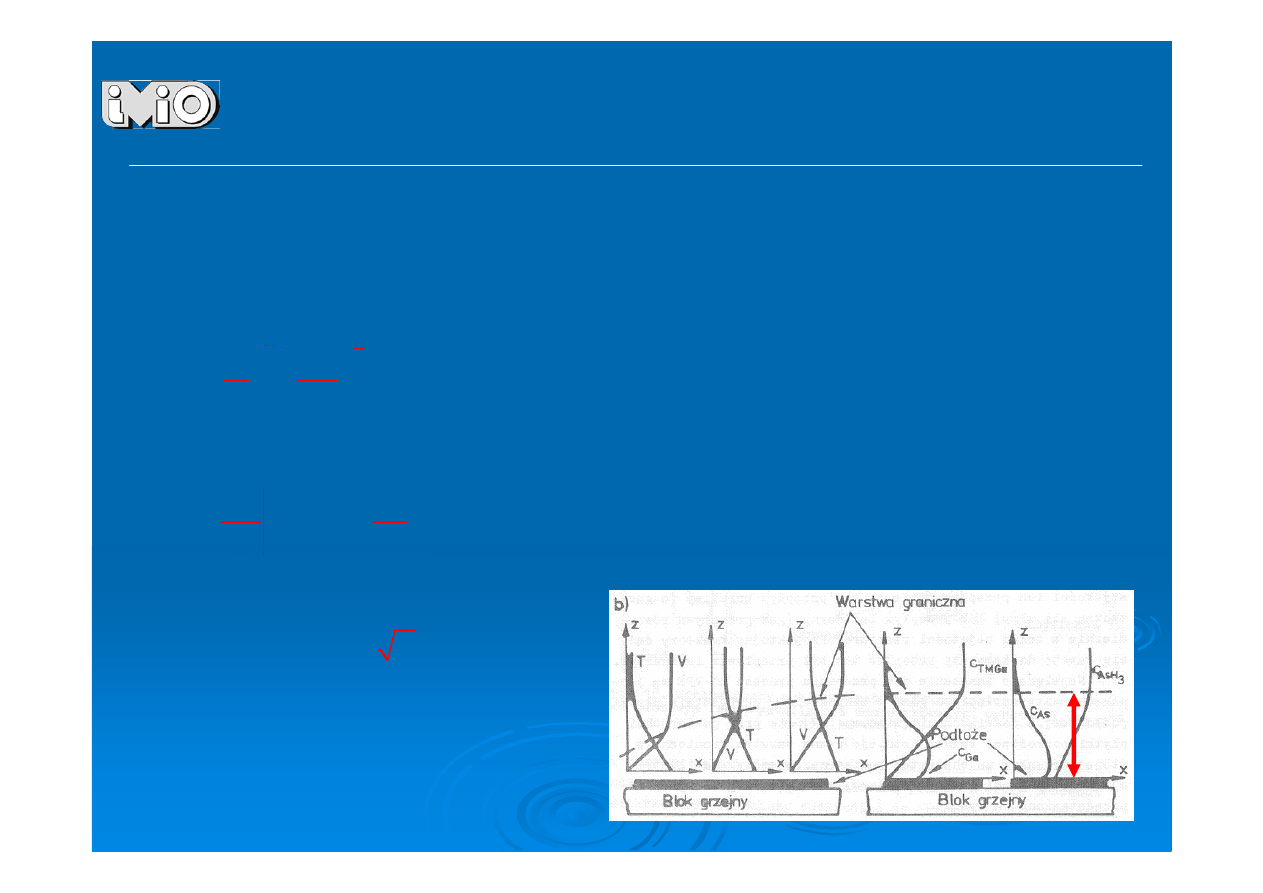
Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
MO CVD
MO CVD
–
–
charakterystyka procesu
charakterystyka procesu
d
D
x
v
μ
δ
μ
⎛ ⎞ ⎛
⎞
=
⎜
⎟
⎜ ⎟
⎝
⎠
⎝ ⎠
1
1
3
2
3
0
= −
−
pow
d
C
dC
F
D
D
dz
δ
.
d
const
v
podł
δ
=
⇒
⇒
δ
(x)
gdzie:
δ
d
– grubość warstwy granicznej
D – współczynnik dyfuzji
μ
– lepkość gazu
v
– prędkość gazu w reaktorze
gdzie: F – strumień docierający do powierzchni
C
0
– koncentracja początkowa pierwiastka ograniczającego
tempo wzrostu warstwy
Ø
( )
d
d
d
f x v
tj
x
x
δ
δ
δ
=
⇒
,
.
;
∼
Ø
M.A. Tischler, IBM J.Res.Dev. 34 (1990) 828
M.A. Herman, w:
„VL
S
I kierunki,…”
, A. Jakubowski (ed.),
PW
N, Warszawa, 1988

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Modyfikacje procesu MO CVD
Modyfikacje procesu MO CVD
G
G
ł
ł
ó
ó
wny problem:
wny problem:
niska stabilno
niska stabilno
ść
ść
termiczna i czasowa zwi
termiczna i czasowa zwi
ą
ą
zk
zk
ó
ó
w
w
metaloorganicznych
metaloorganicznych
(
(
polimeryzacja, hydroliza itp.
polimeryzacja, hydroliza itp.
)
)

Zak
Zak
ł
ł
ad Przyrz
ad Przyrz
ą
ą
d
d
ó
ó
w Mikroelektroniki i Nanoelektroniki,
w Mikroelektroniki i Nanoelektroniki,
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
Instytut Mikroelektroniki i Optoelektroniki Politechniki Warszaw
skiej
skiej
Modyfikacje procesu MO CVD
Modyfikacje procesu MO CVD
1. MO CVD ze
1. MO CVD ze
ź
ź
r
r
ó
ó
de
de
ł
ł
jednosk
jednosk
ł
ł
adnikowych:
adnikowych:
proszki, pr
proszki, pr
ę
ę
ty, roztwory (w rozpuszczalnikach
ty, roztwory (w rozpuszczalnikach
organicznych,
organicznych,
np
np
. w heksanie)
. w heksanie)
Ø
Ø
odparowywanie
odparowywanie
„
„
b
b
ł
ł
yskowe
yskowe
”
”
niewielkich ilo
niewielkich ilo
ś
ś
ci prekursora w
ci prekursora w
rozgrzanych do wysokich temperatur parownikach
rozgrzanych do wysokich temperatur parownikach
2.
2.
Pulsed
Pulsed
Injection
Injection
MOCVD:
MOCVD:
impulsowe dozowanie niewielkich (~ mg) dawek
impulsowe dozowanie niewielkich (~ mg) dawek
roztwor
roztwor
ó
ó
w
w
prekursor
prekursor
ó
ó
w do parownika
w do parownika
Document Outline
- WYTWARZANIE ULTRACIENKICH WARSTW
- Epitaksja vs. endotaksja
- Techniki CVD
- Techniki CVD – niektóre uwarunkowania krytyczne
- Techniki PVD
- Techniki PVD – niektóre uwarunkowania krytyczne
- Dynamika procesu epitaksji
- Czynniki kontrolujące proces wzrostu warstw z fazy gazowej
- Wzrost epitaksjalny – faza początkowa
- Wzrost epitaksjalny – faza początkowa
- Wzrost epitaksjalny – faza początkowa
- Wzrost epitaksjalny – faza początkowa
- Wzrost epitaksjalny – powstawanie wysp – zaleta czy wada?
- Wzrost epitaksjalny – powstawanie wysp – zaleta czy wada?
- Wzrost epitaksjalny – wybrane zagadnienia
- Wzrost epitaksjalny – wybrane zagadnienia
- Wzrost epitaksjalny na powierzchniach wicynalnych
- Wzrost epitaksjalny na powierzchniach wicynalnych
- Wzrost warstwy typu „step flow”
- Wzrost warstwy typu „step flow” – niestabilność progu
- Przykłady procesów wytwarzania ultracienkich warstw
- MBE
- MBE – czystość!
- MBE- procesy kinetyczne na podłożu podczas wzrostu warstwy
- MBE- procesy kinetyczne na podłożu podczas wzrostu warstwy
- MBE – komora wzrostu warstwy
- MBE
- MBE – komórki efuzyjne
- MBE – wybrane zagadnienia konstrukcyjno-technologiczne
- MBE – wybrane zagadnienia konstrukcyjno-technologiczne
- MBE – komórki efuzyjne modułowe
- MBE – komórki efuzyjne modułowe
- MBE - przesłony
- MBE – montaż płytek podłożowych
- MBE – pomiar temperatury podłoży
- MBE – równomierny rozkład wiązki
- MBE – kontrola procesu epitaksji
- MBE – kontrola procesu epitaksji
- MBE – wybrane modyfikacje
- MBE – wybrane modyfikacje
- MO CVD
- MO CVD i OM CVD
- MO CVD – cechy charakterystyczne procesu
- Dlaczego MO CVD (procesy pod obniżonym ciśnieniem)
- MO CVD – charakterystyka procesu
- MO CVD – charakterystyka procesu
- MO CVD – charakterystyka procesu
- Modyfikacje procesu MO CVD
- Modyfikacje procesu MO CVD
Wyszukiwarka
Podobne podstrony:
C102012 F W0064 TGA Part4
ATSG A604 Part4
Part4 Intro to Japanese Grammer
PART4
Part4 (3)
Eurocode 2 Design of concrete structures part4
catalog GrippingModules 0901 Part4 970 1364 EN
PART4 (4)
C102012 F W0064 TGA Part4
ATSG A604 Part4
Eurocode 2 Design of concrete structures part4
dl44 Part4
C102012 F W0064 TGA Part4
LucasServicemanual noSB519 part4
Part4
ATSG A604 Part4
więcej podobnych podstron