
W.2_VLSI FABRICATION
TECHNOLOGY
UKŁADY
SCALONE
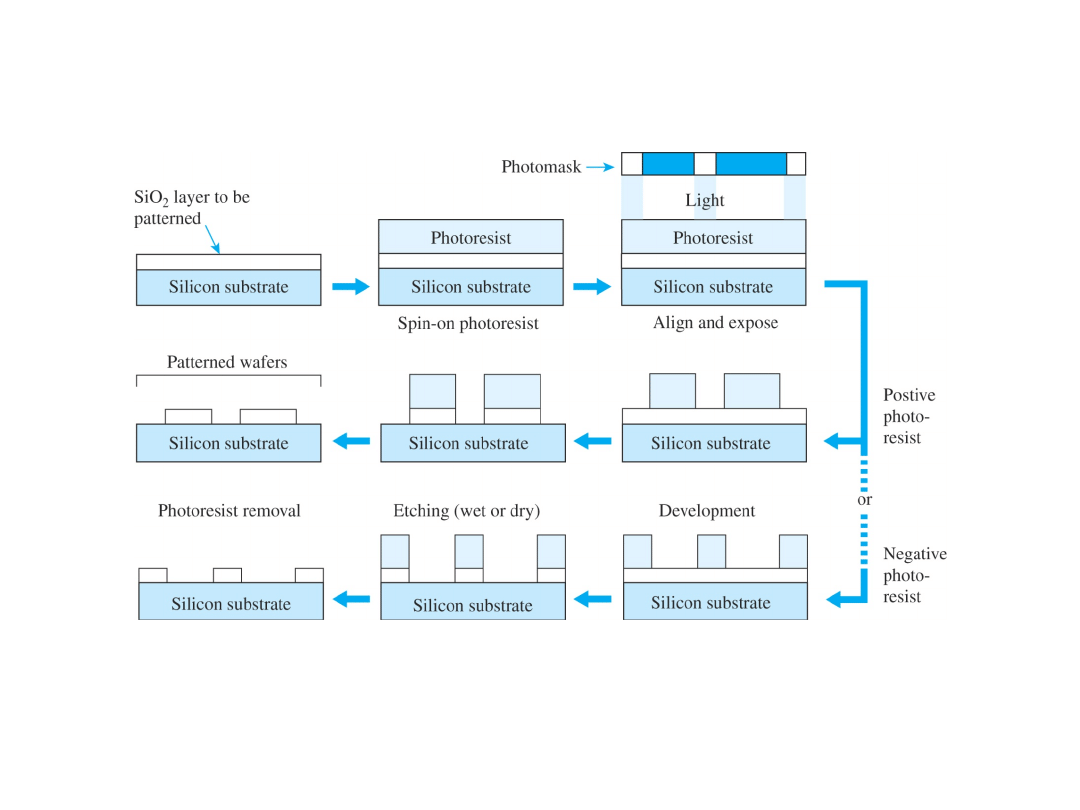
Fig.1 Photolithography using positive or negative photoresist.

Fig.2 Conceptual illustration of a step-and-repeat reduction
technique to facilitate the mass production of integrated circuits.
Maska
pozycjonowana
w osi pionowej
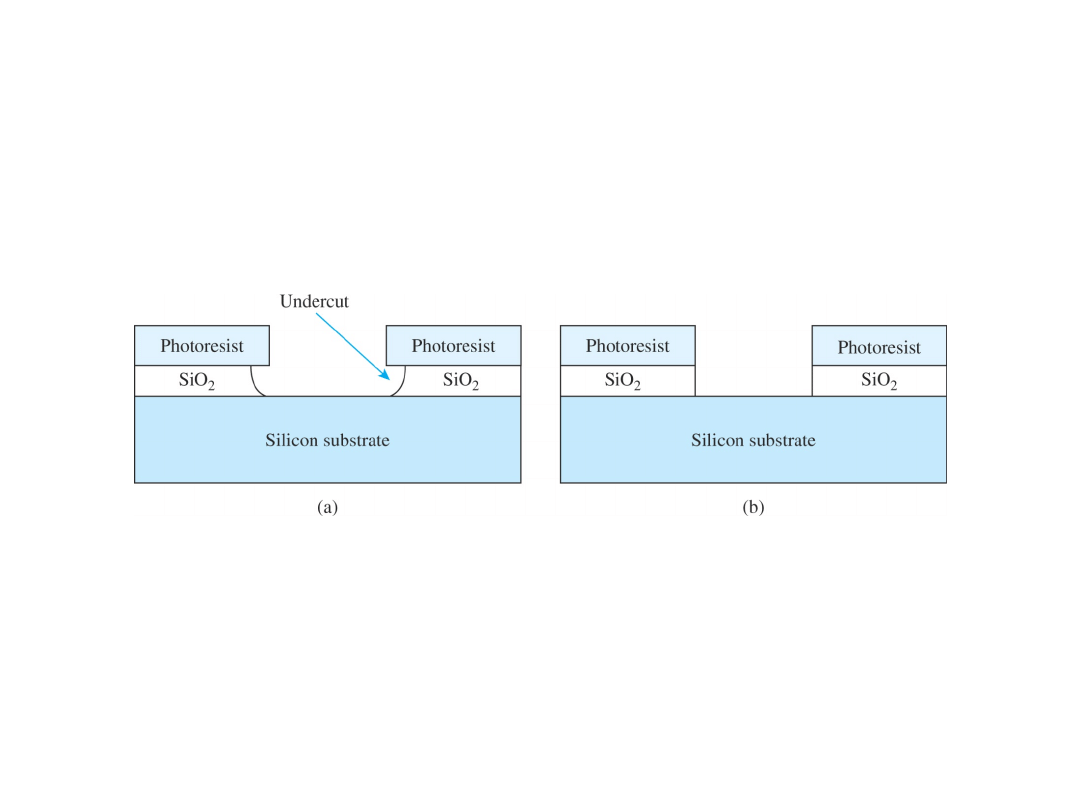
Fig.3 (a) Cross-sectional view of an isotropic oxide etch with severe
undercut beneath the photoresist layer. (b) Anisotropic etching,
which usually produces a cross section with no undercut.

Fig.4. Examples of an 8-pin plastic dual-in-line IC package and a
16-pin surface-mount package.
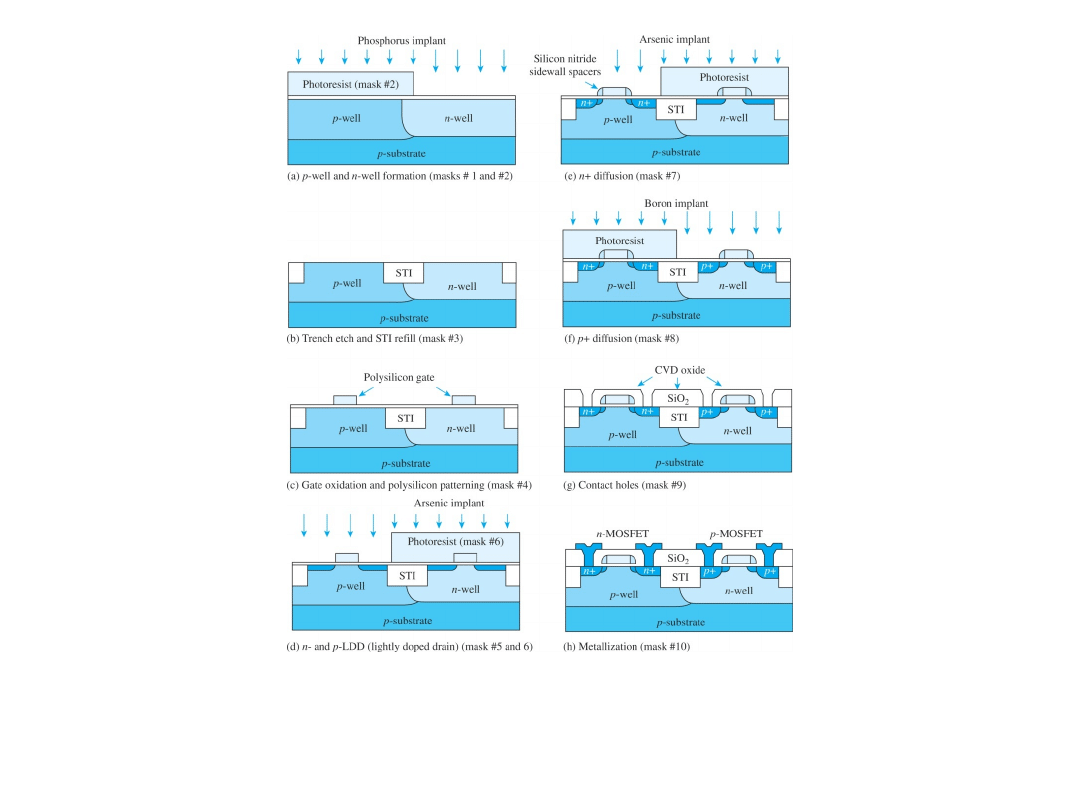
Fig.5 A modern twin-well CMOS process flow with shallow trench
isolation (STI).
Implantacja
wysokoenergetyczna
Implantacja
niskoenergetyczna
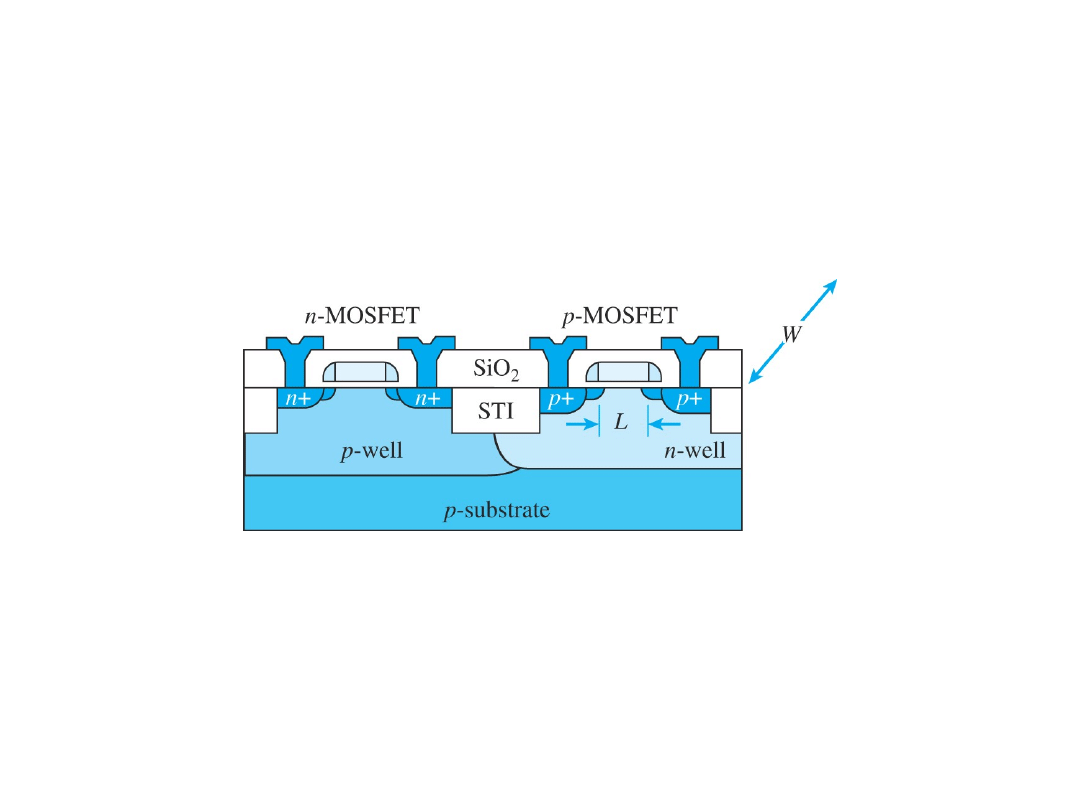
Fig.6 Cross-sectional diagram of n- and p-MOSFETs.
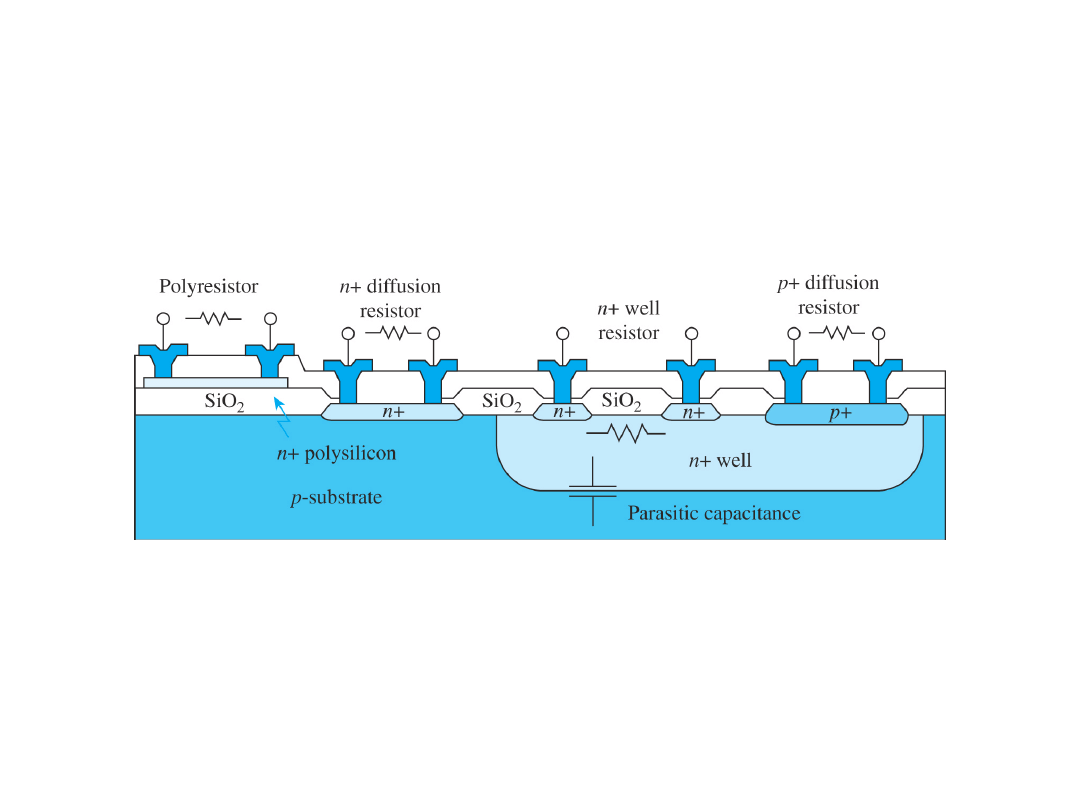
Fig.7 Cross sections of various resistor types available from a
typical
n-well CMOS process.
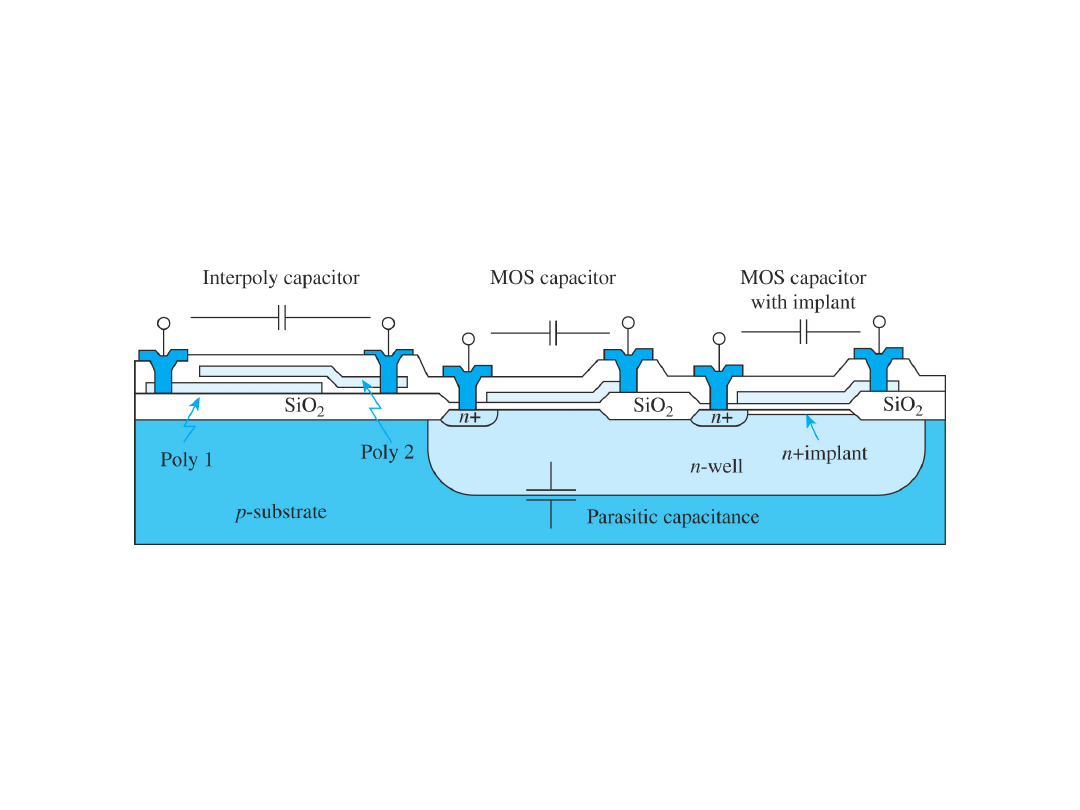
Fig.8 Interpoly and MOS capacitors in an n-well CMOS process.
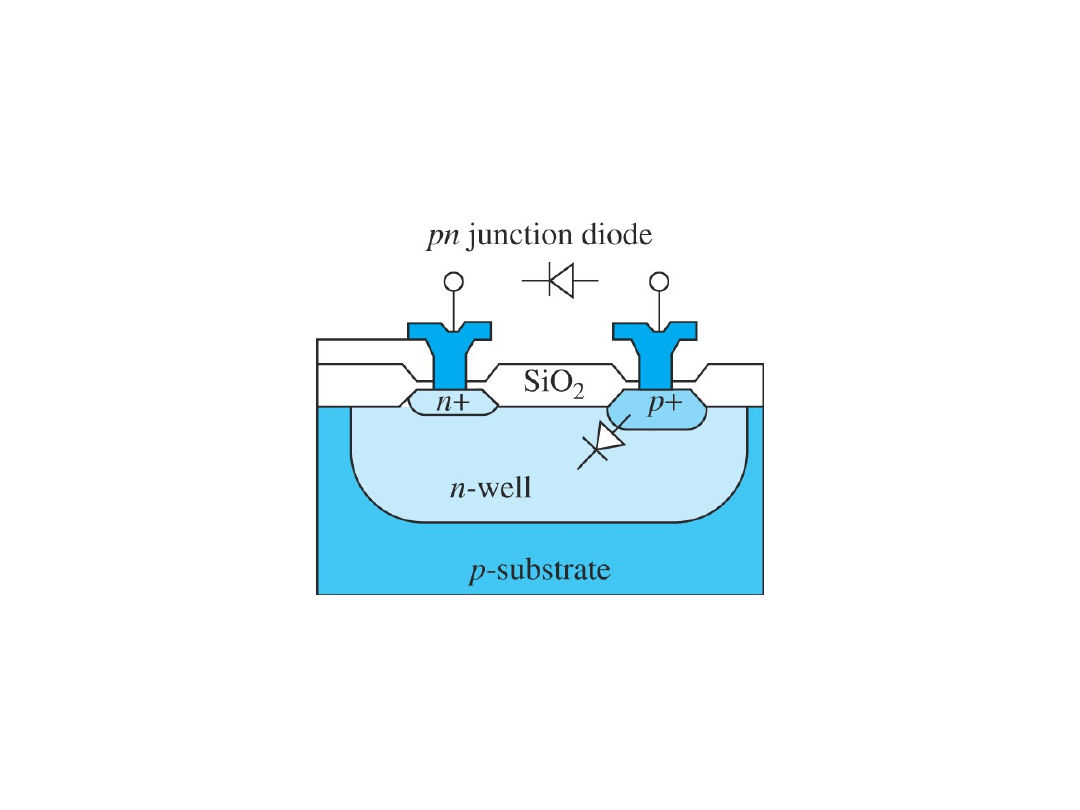
Fig.9 A pn junction diode in an n-well CMOS process.
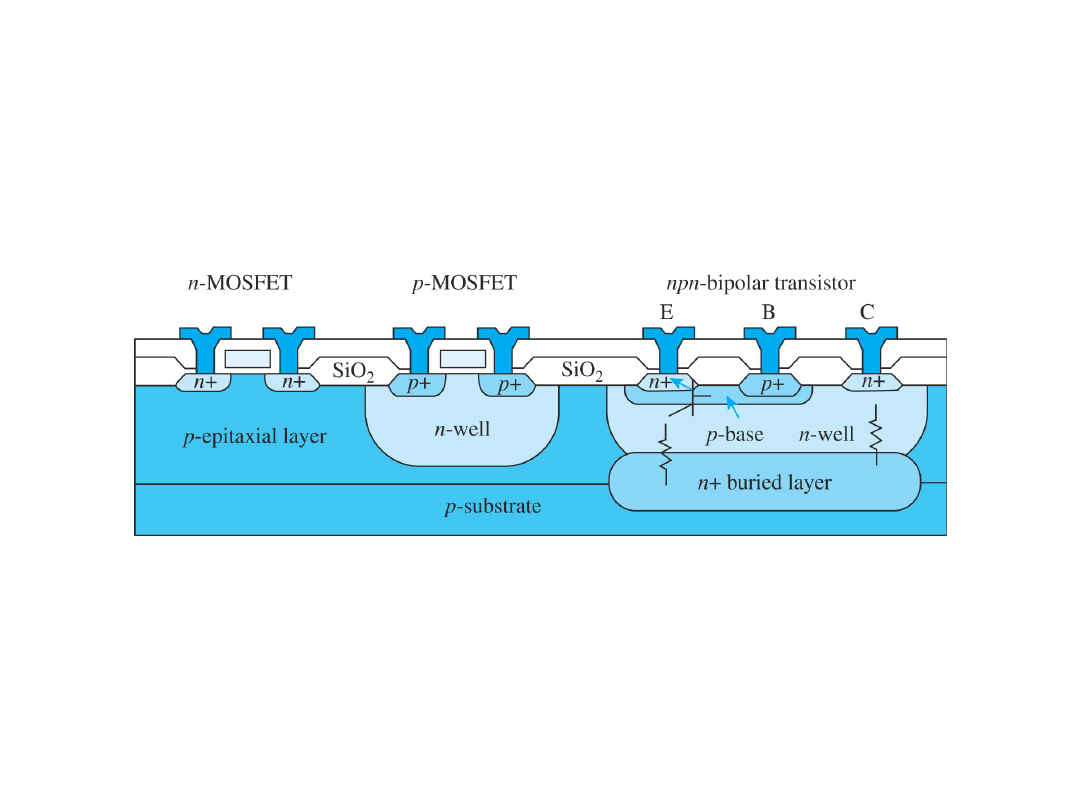
Fig.10 Cross-sectional diagram of a BiCMOS process.
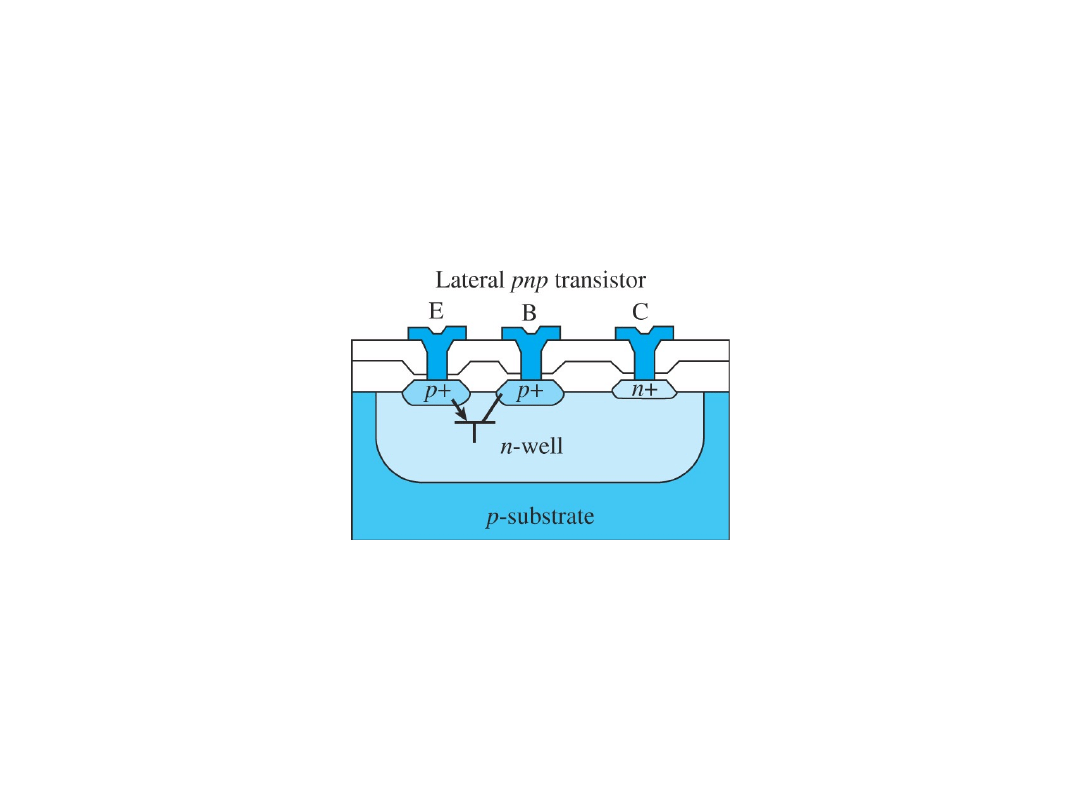
Fig.11 Lateral pnp transistor.
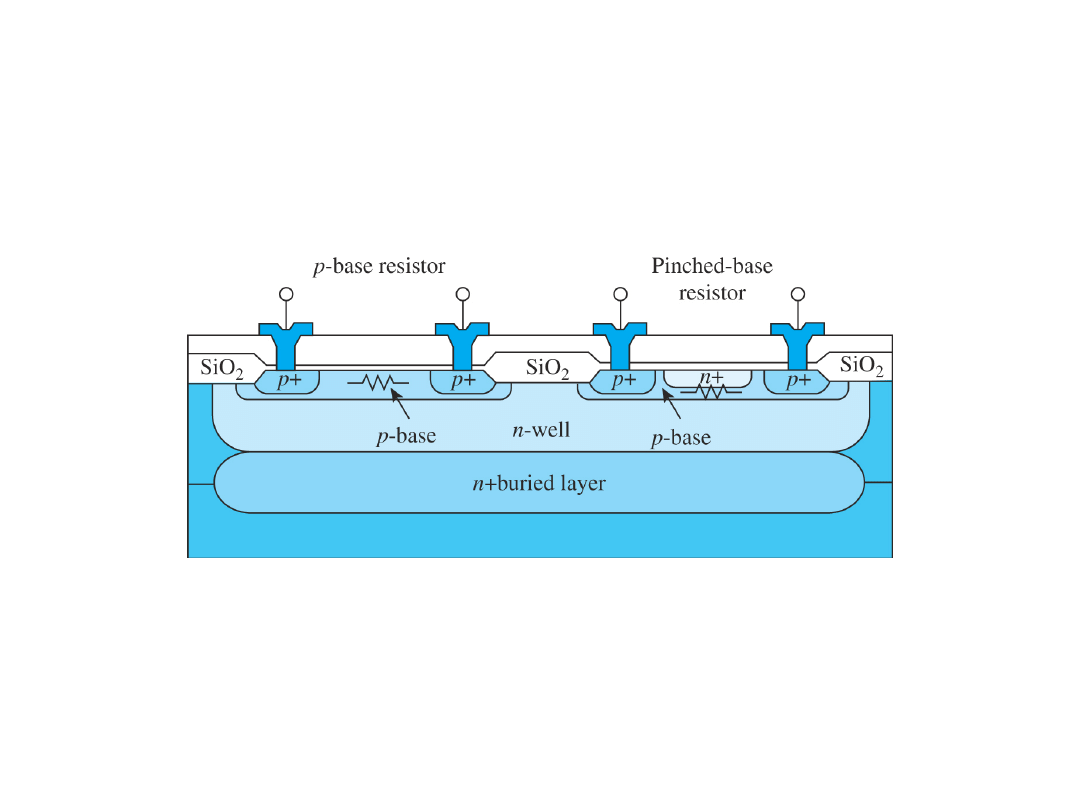
Fig.12 p-base and pinched p-base resistors.
spłaszczony
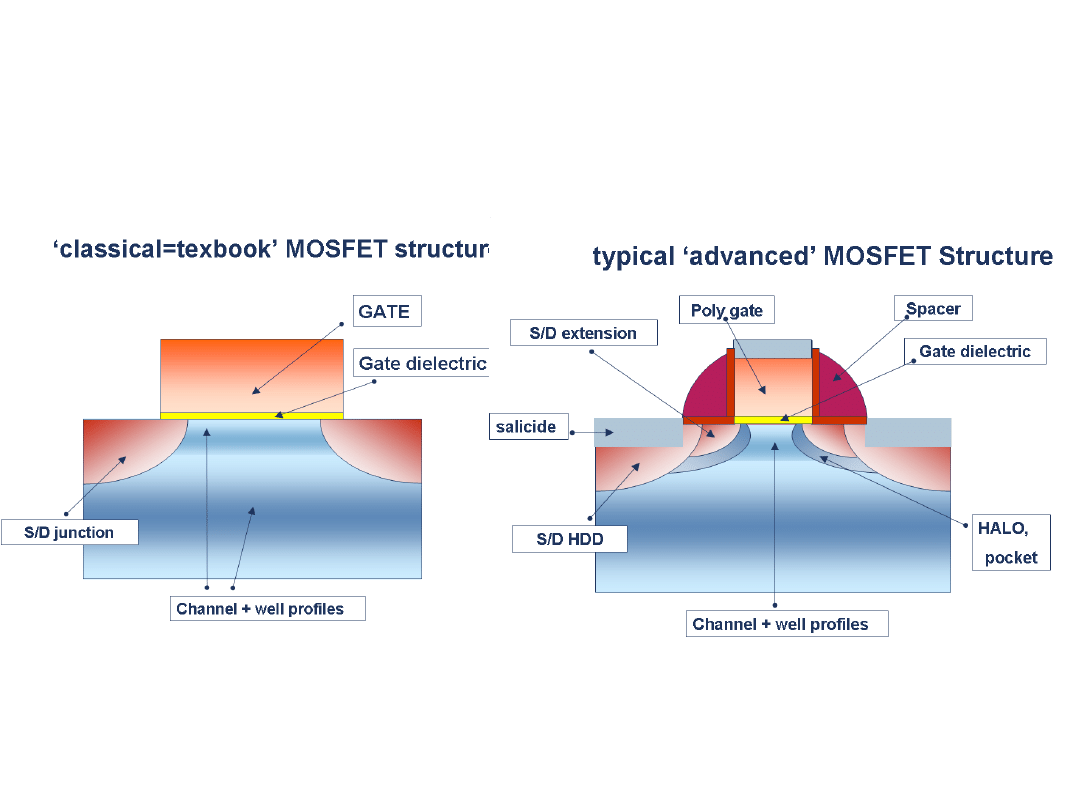
Struktury tranzystorów MOSFET:
a) z długim kanałem, b) z krótkim kanałem
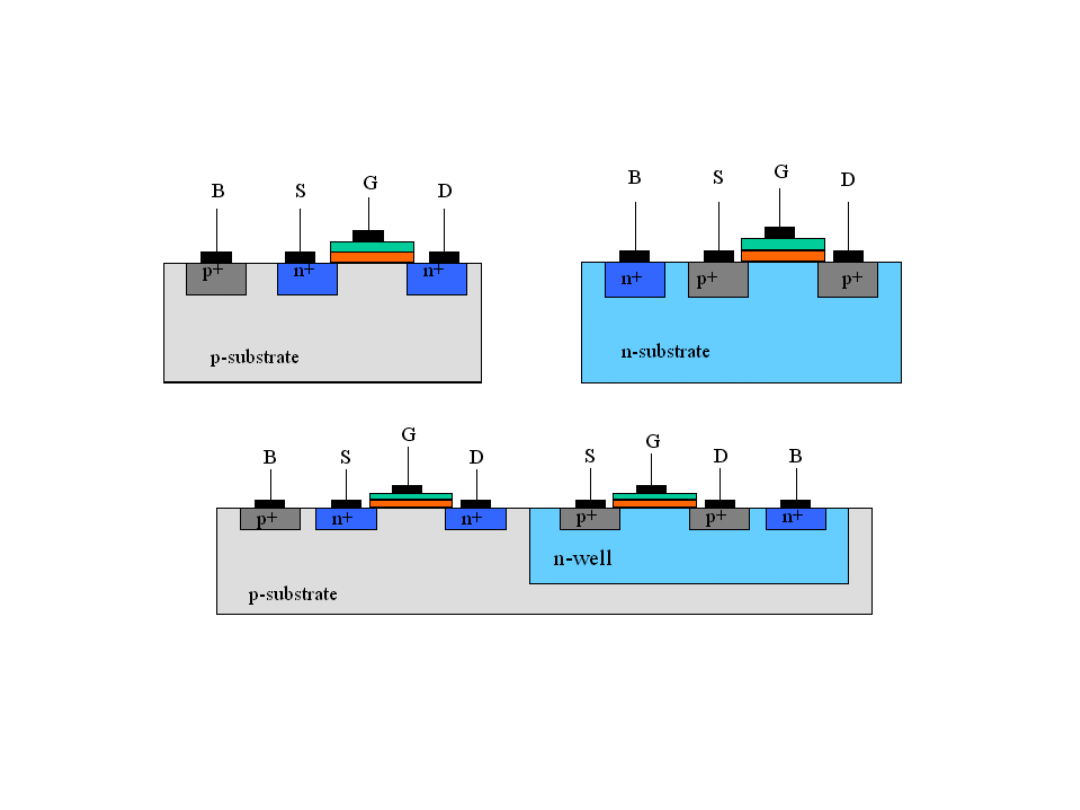
Podstawowa technologia cyfrowa
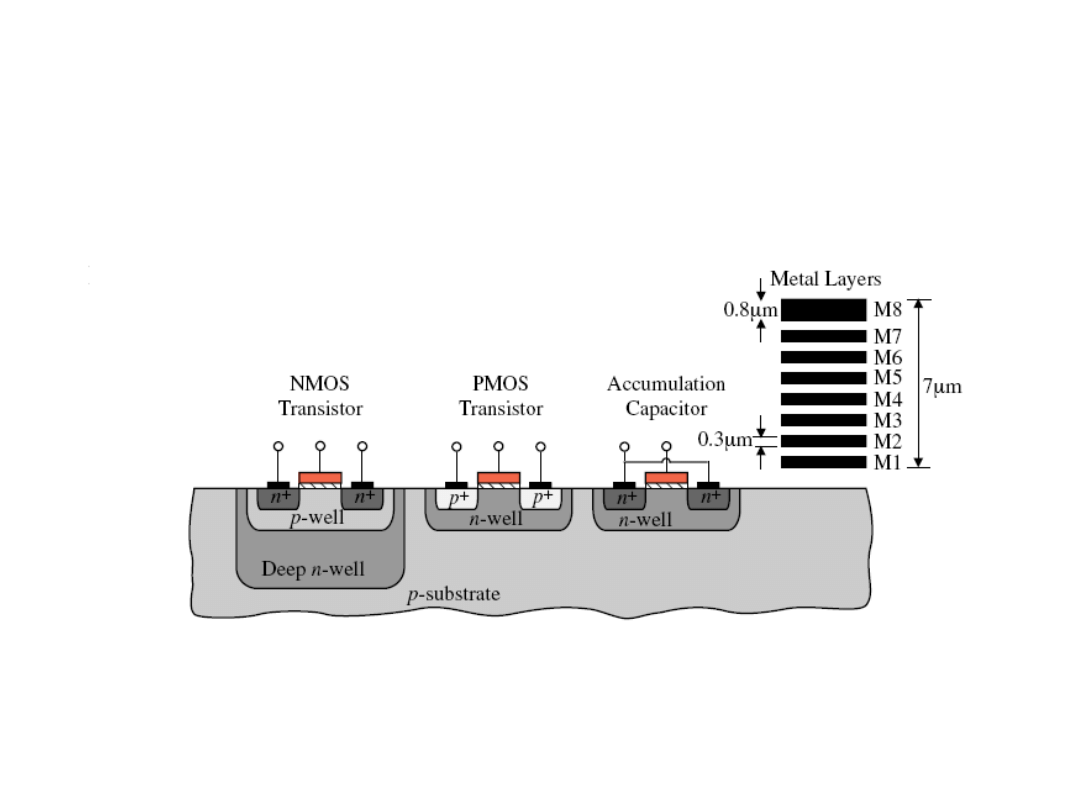
Elementy we współczesnych
technologiach CMOS
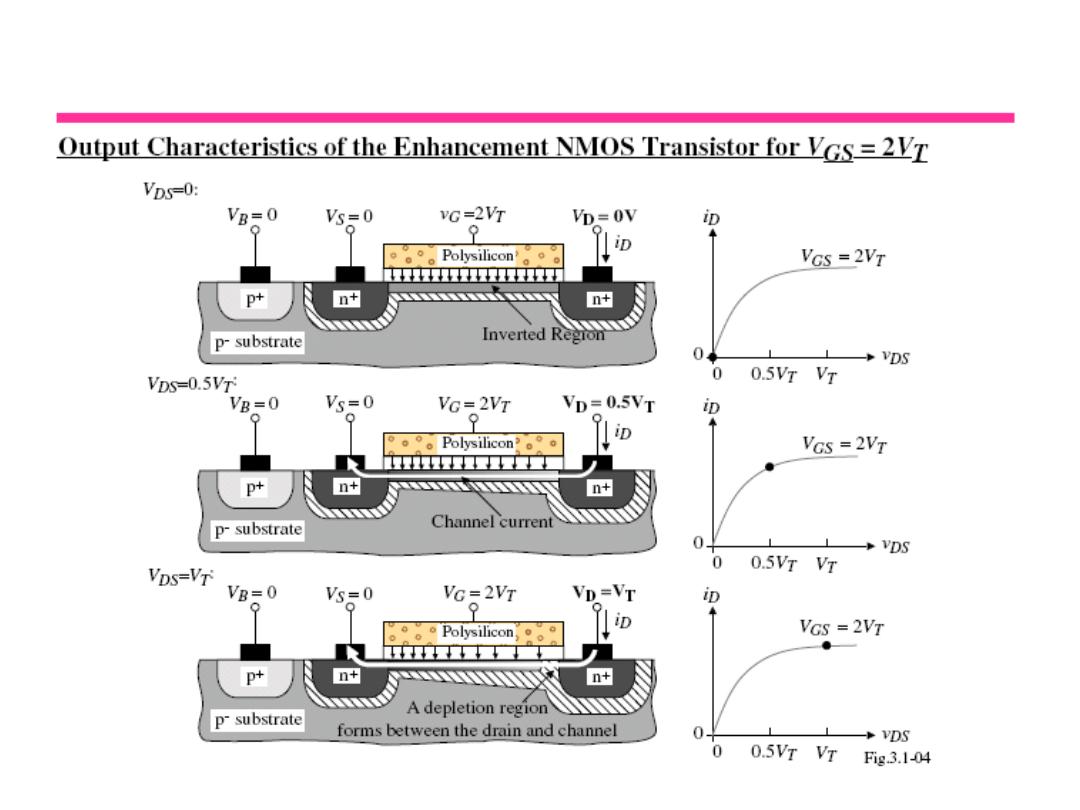
Wielkosygnałowy model
tranzystora MOS
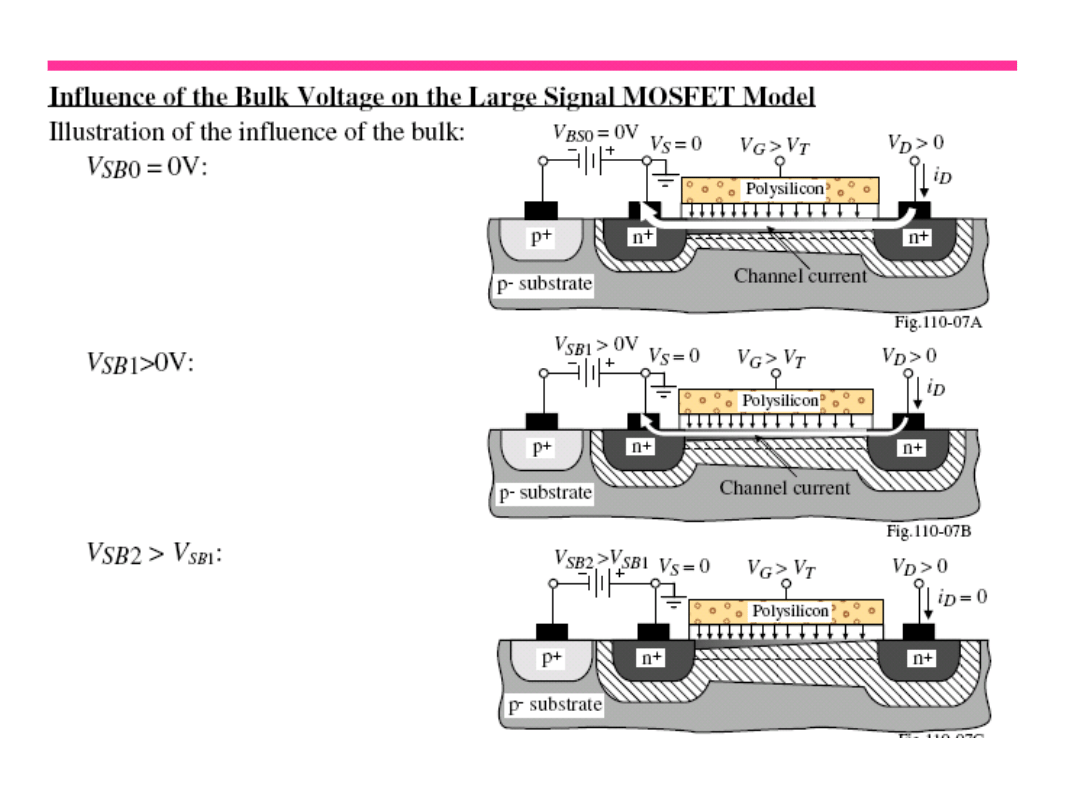
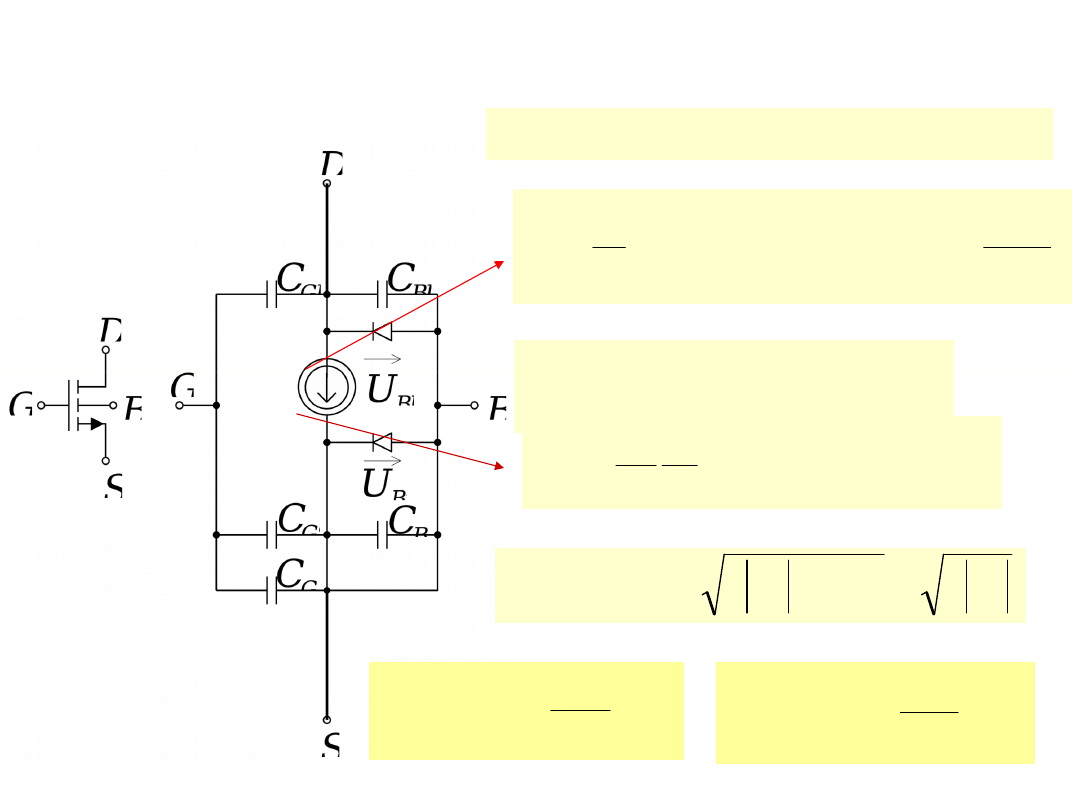
Wielkosygnałowy model Schichmana – Hodgesa
MOSFET
I
W
L
C
U
U U
U
D
ox
GS
T
DS
DS
2
2
dla U
GS
> U
T
i 0 < U
DS
< U
GS
- U
T
DS
T
GS
Dsat
U
U
U
L
W
K
I
1
2
2
'
dla U
GS
> U
T
i U
DS
> U
GS
-U
T
f
BS
f
T
T
U
U
U
2
2
0
I
I
U
BD
s
BD
T
exp
1
I
I
U
BS
s
BS
T
exp
1
I
D

K’ =
Cox - parametr transkonduktancyjny,
U
T0
- napięcie progowe przy napięciu podłoże-źródło
U
BS
=0,
- współczynnik objętościowy napięcia progowego,
- współczynnik modulacji długości kanału w [V
-
0,5
],
- potencjał powierzchniowy przy silnej inwersji
półprzewodnika
f
2
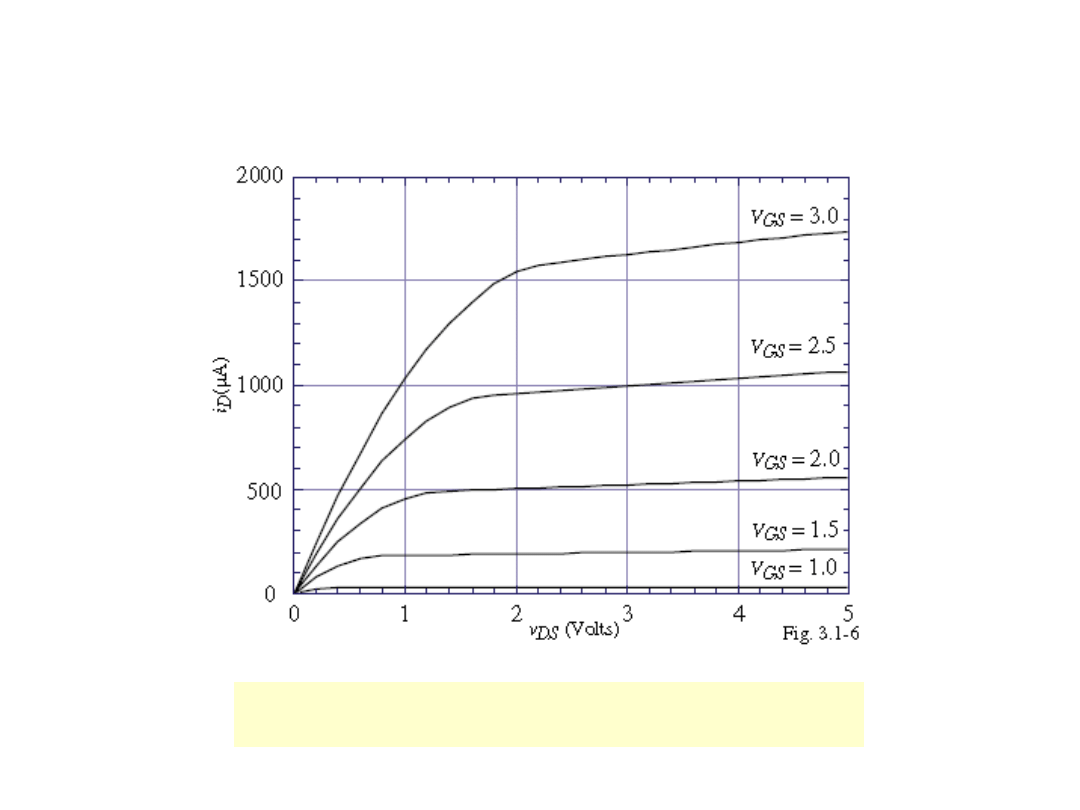
const
przy
)
(
GS
DS
D
u
u
f
i
CHARAKTERYSTYKI WYJŚCIOWE
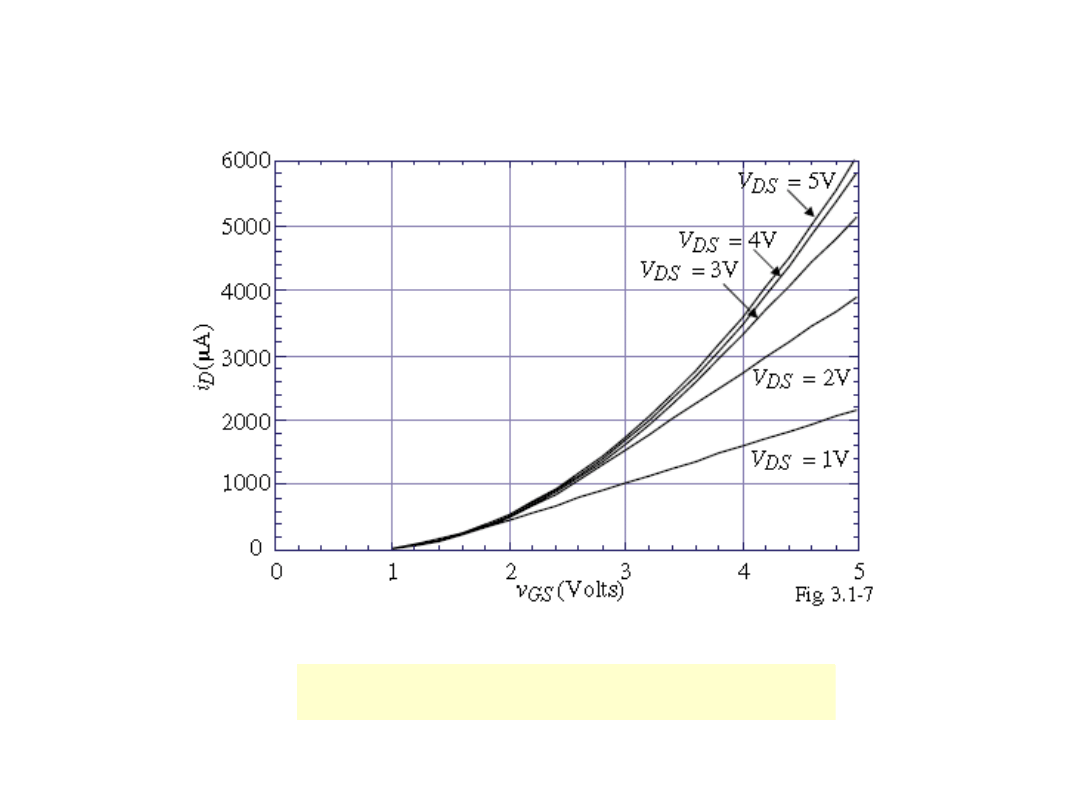
const
przy
)
(
DS
GS
D
u
u
f
i
CHARAKTERYSTYKI PRZEJŚCIOWE
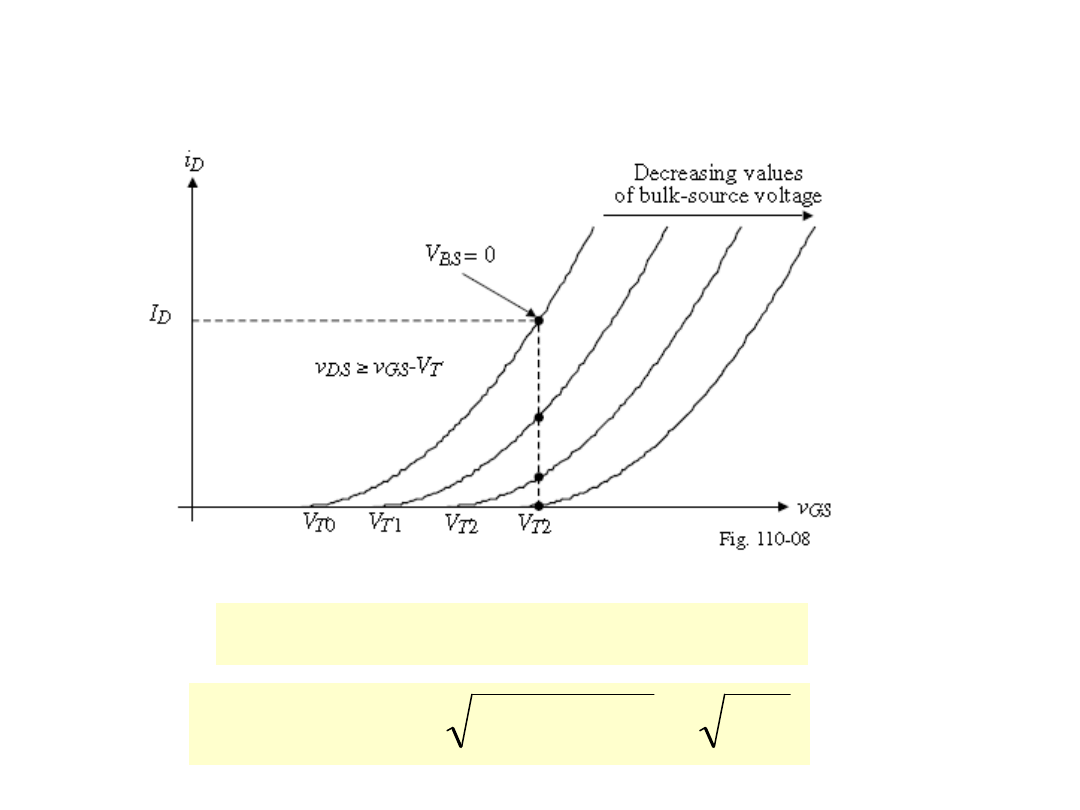
const
przy
)
(
BS
GS
D
u
u
f
i
WPŁYW NAPIĘCIA PODŁOŻE – ŹRÓDŁO NA
PRĄD DRENU
U
U
U
T
T
si
BS
si
0
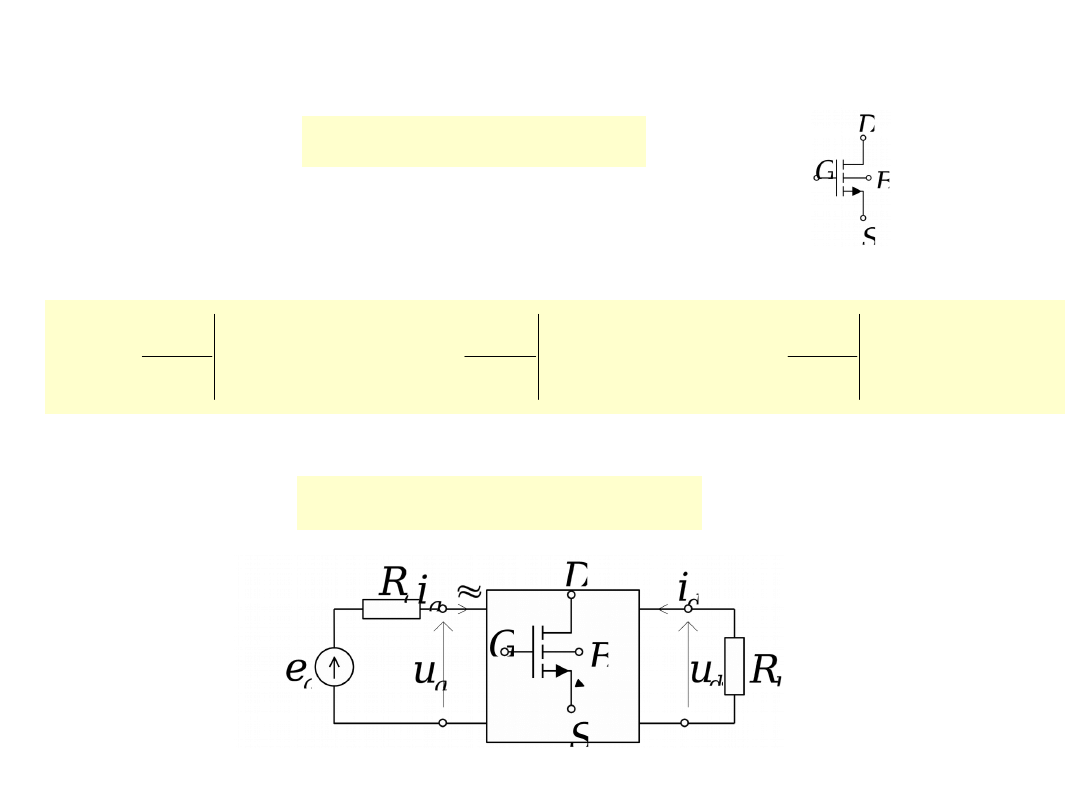
Charakterystyki małosygnałowe
BS
const
U
U
BS
D
DS
const
U
U
DS
D
GS
const
U
U
GS
D
D
U
U
I
U
U
I
U
U
I
I
DS
GS
BS
GS
DS
DS
;
;
;
Tranzystor jako czwórnik aktywny
)
,
,
(
DS
DS
GS
D
U
U
U
f
I
Dla układu
OS:
bs
mb
ds
ds
gs
m
d
u
g
u
g
u
g
i
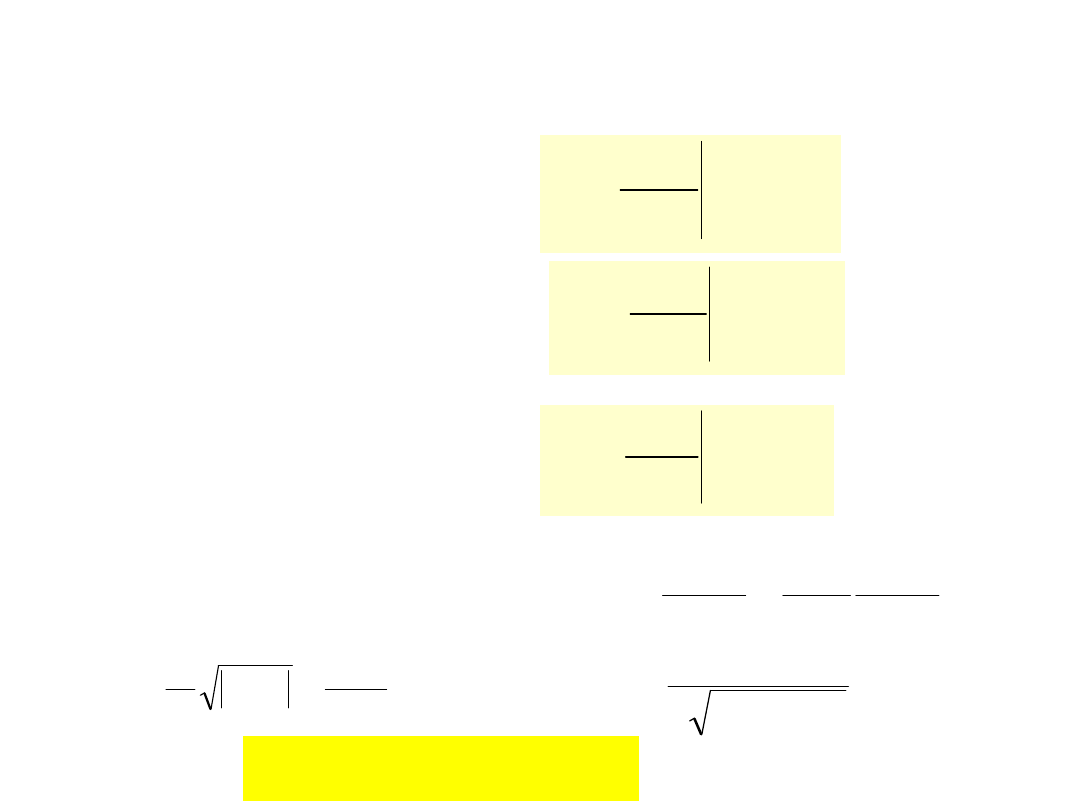
Małosygnałowy model tranzystora MOSFET
const
,
BS
DS
U
U
GS
D
m
U
I
g
const
,
BS
GS
U
U
DS
D
ds
U
I
g
const
,
GS
DS
U
U
BS
D
mb
U
I
g
Transkonduktancja:
Konduktancja wyjściowa:
Transkonduktancję
wynikającą z wpływu
napięcia U
BS :
g
K
W
L
I
K W
L
U
U
m
Dsat
GS
T
2 '
'
g
I
U
I
U
U
U
mb
D
BS
D
T
T
BS
m
BS
si
m
mb
g
U
g
g
2
ds
mb
m
g
g
g
100
10
g
I
ds
D

MAŁOSYGNAŁOWY MODEL TRANZYSTORA
MOSFET
Z UWZGLĘDNIENIEM EFEKTU PODŁOŻA

Małosygnałowy model tranzystora MOSFET
w zakresie wielkich częstotliwości,
bez uwzględnienia efektu podłoża
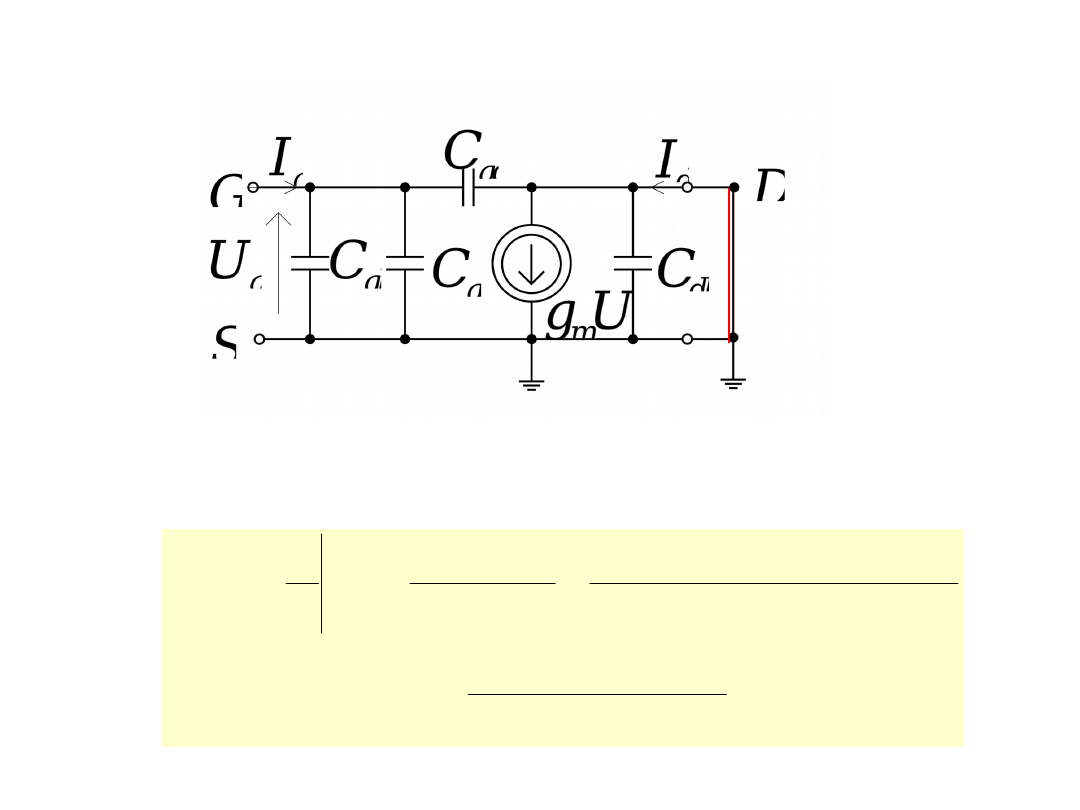
Częstotliwość odcięcia f
T
jest częstotliwością przy której prąd
wejściowy I
g
jest równy prądowi źródła sterowanego g
m
U
gs
tranzystora przy zwartym wyjściu.
Częstotliwość graniczna f
T
tranzystora
MOSFET
gb
gd
gs
m
T
i
gd
gb
gs
gs
gs
m
g
gs
m
U
g
d
i
C
C
C
g
f
j
k
C
C
C
j
j
U
j
U
g
j
I
j
U
g
I
I
j
k
ds
2
dla
1
0
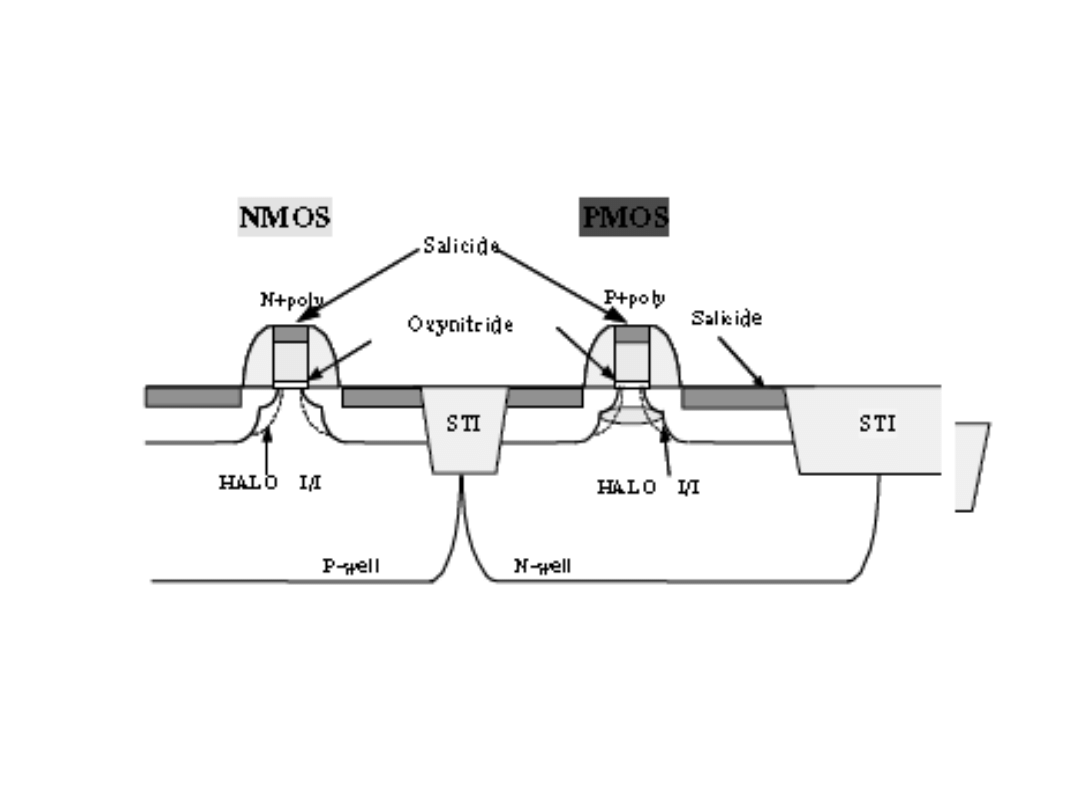
Przekrój poprzeczny tranzystorów NMOS i PMOS z krótkim
kanałem wykonanych w zaawansowanej technologii z płytką
izolacją rowkową STI
(
Shallow Trench Isolation)
Warstwy „salicide” (niskorezystywne
warstwy krzemianów: np. TiSi2, W Si2, W
Si2, TaSi2)
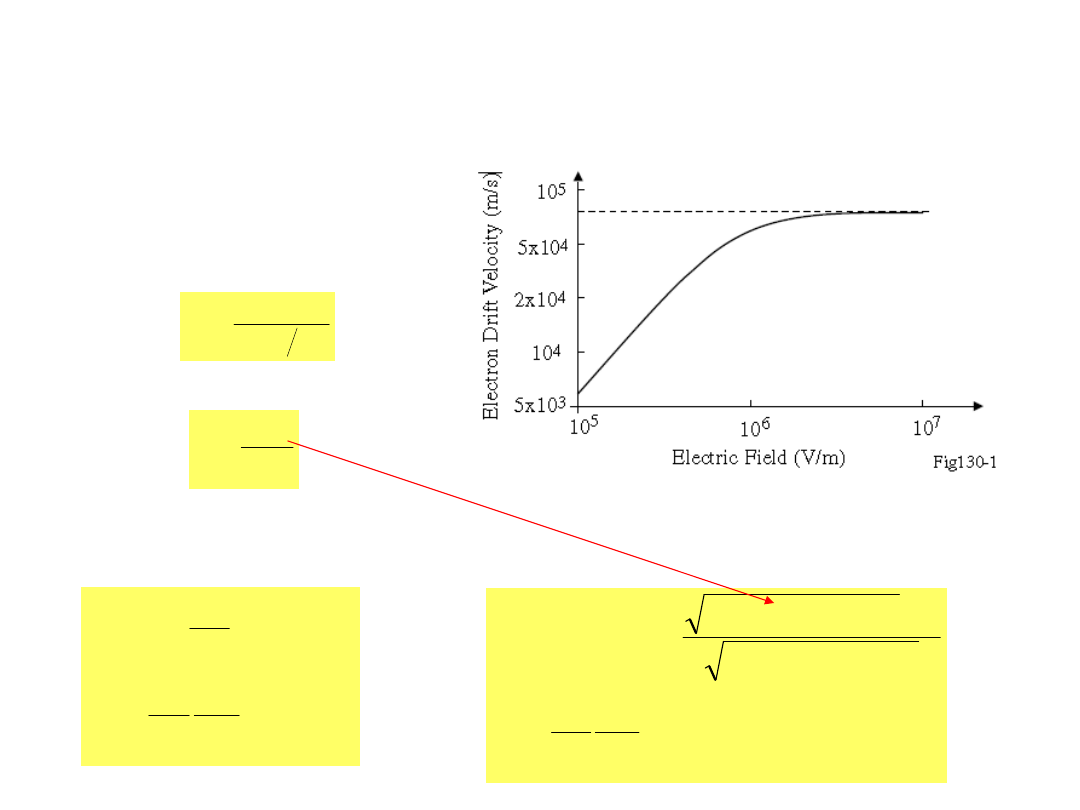
Tranzystory MOS z krótkim kanałem
c
n
d
E
E
E
v
1
2
'
2
1
2
L
C
g
f
V
V
L
W
K
g
gs
m
T
T
GS
m
1
2
1
2
1
1
2
1
L
C
g
f
V
V
V
V
E
WC
g
gs
m
T
T
GS
T
GS
c
o
ox
m
Prędkość poruszania się
elektronów:
Nie ma nasycenia ruchliwości
nośników
Występuje nasycenia ruchliwości nośników
c
LE
1
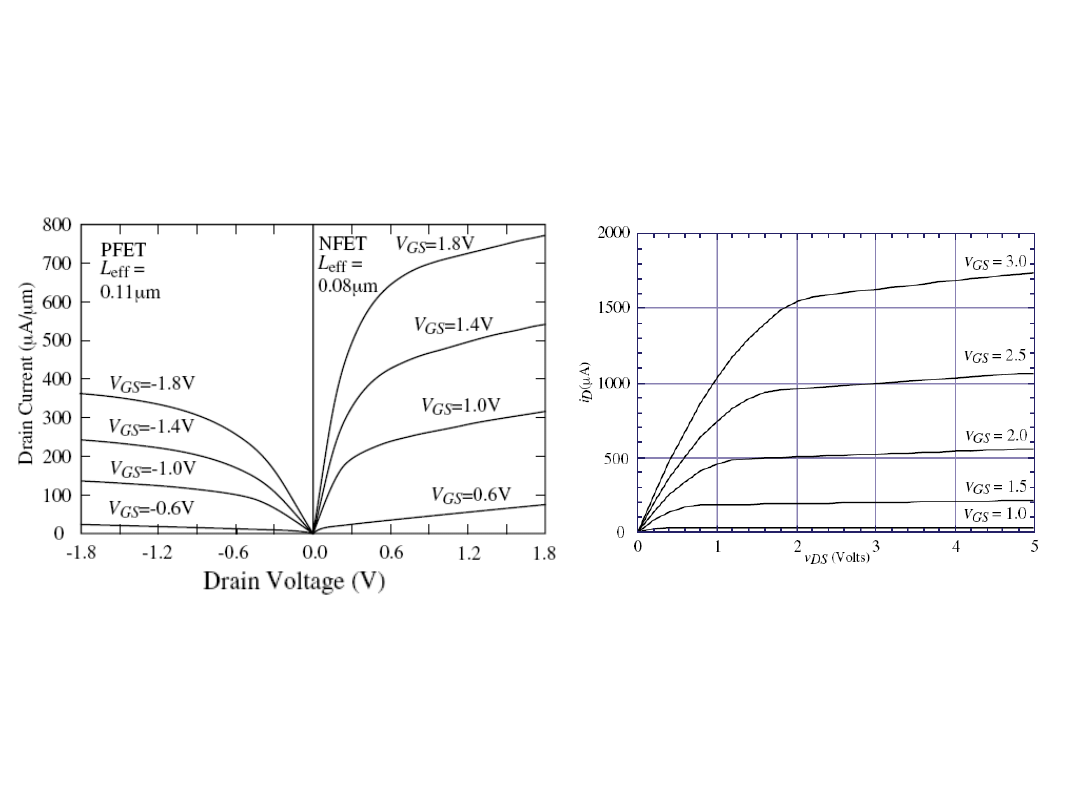
Przykładowe charakterystyki
wyjściowe tranzystorów z kanałem
wzbogacanym
Tranzystor z krótkim kanałem Tranzystor bez efektu
krótkiego kanału
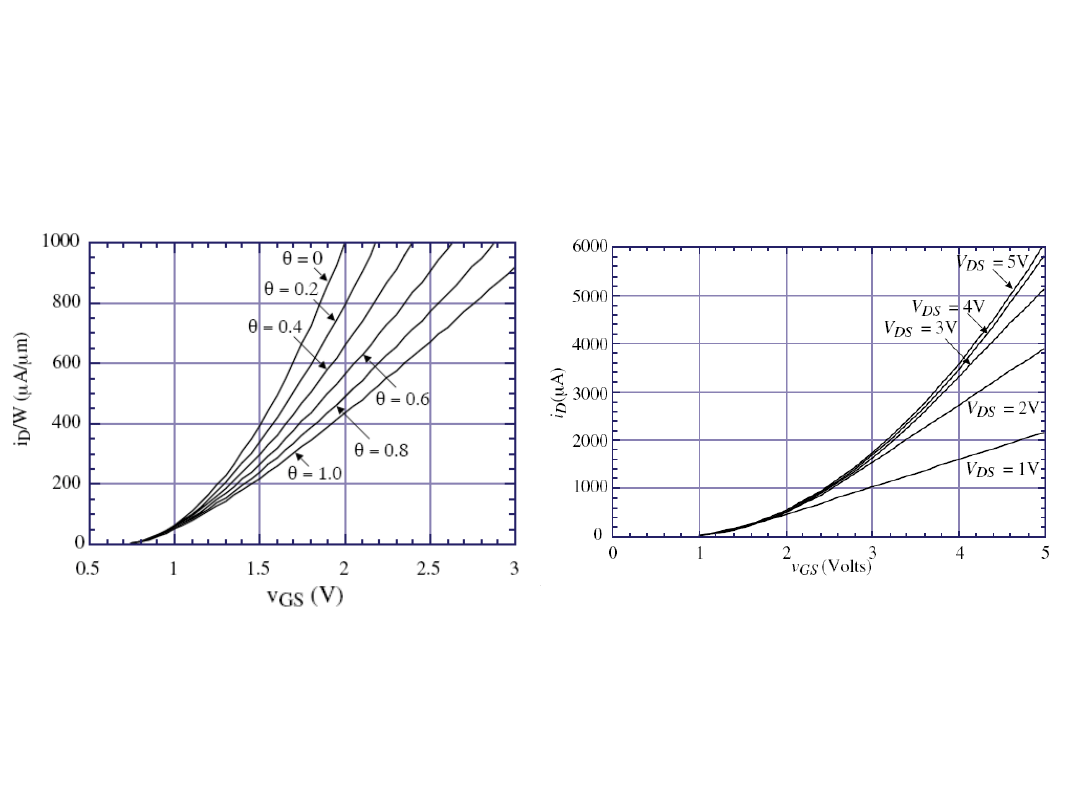
Przykładowe
charakterystyki
przejściowe
tranzystora NMOS z kanałem
wzbogacanym
Tranzystor z krótkim kanałem Tranzystor bez efektu
krótkiego kanału
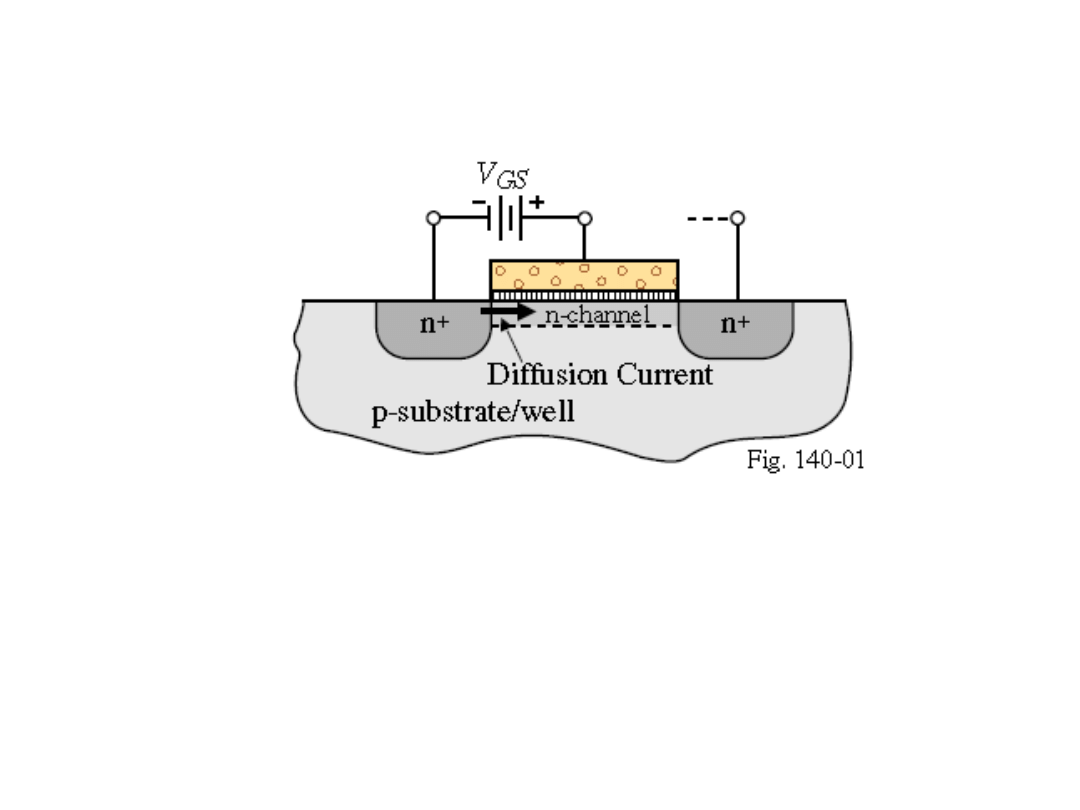
ZAKRES PODPROGOWY PRACY
TRANZYSTORA MOSFET
Zakresy pracy zależne są od potencjału powierzchniowego ϕ
S
przy
silnej inwersji półprzewodnika:
ϕ
S
< ϕ
F
; Brak inwersji podłoża
ϕ
S
< ϕ
F
< 2 ϕ
F
; Słaba inwersja kanału (płynie prąd dyfuzyjny do
drenu)
2ϕ
S
< ϕ
F
; Silna inwersja kanału (płynie prąd dryftowy do
drenu)
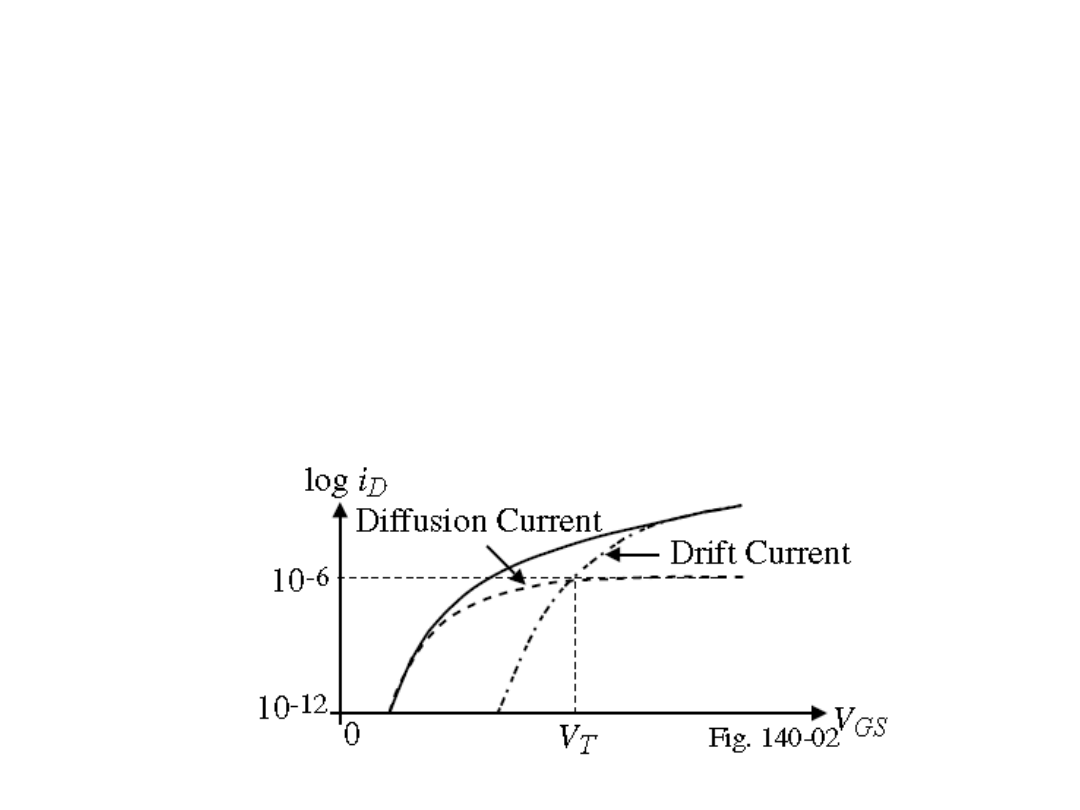
PRĄD DRENU - DRYFTOWY PRZY SILNEJ INWERSJI
PRĄD DRENU - DYFUZYJNY PRZY SŁABEJ INWERSJI
1). Przy silnej inwersji, napięcie bramki steruje ładunkiem w obszarze
inwersyjnym, tj w obszarze wyindukowanego kanału, a nie wpływa na
ładunek w obszarze zubożonym. Koncentracja ładunku w kanale jest
prawie stała, prąd dryftowy drenu płynie pod wpływem pola elektrycznego
w kanale.
2). Przy słabej inwersji, ładunek w kanale jest znacznie mniejszy niż w
obszarze zubożonym i
dryftowy prąd drenu jest znikomy
. Jednakże na
skutek gradientu koncentracji ładunku w kanale, płynie prąd dyfuzyjny
drenu. (Źródło S tranzystora jest obszarem n
+
i zachowuje się podobnie jak
emiter tranzystora bipolarnego.

A
DS
t
T
GS
t
D
V
V
nV
V
v
L
W
I
i
1
exp
WIELKOSYGNAŁOWY MODEL DLA SŁABEJ
INWERSJI
Jeżeli: v
DS
> 0, to:
S
źródła
n
warstwy
ć
grubos
yczny,
termokinet
potencja
ł
1
3
5
,
1
exp
:
gdzie
'
1
2
2
1
2
0
X
V
n
V
k
k
k
n
V
v
k
n
v
n
C
C
C
dv
d
n
V
k
n
qXD
I
t
T
T
GS
GS
S
jS
ox
ox
GS
S
t
p
n
t
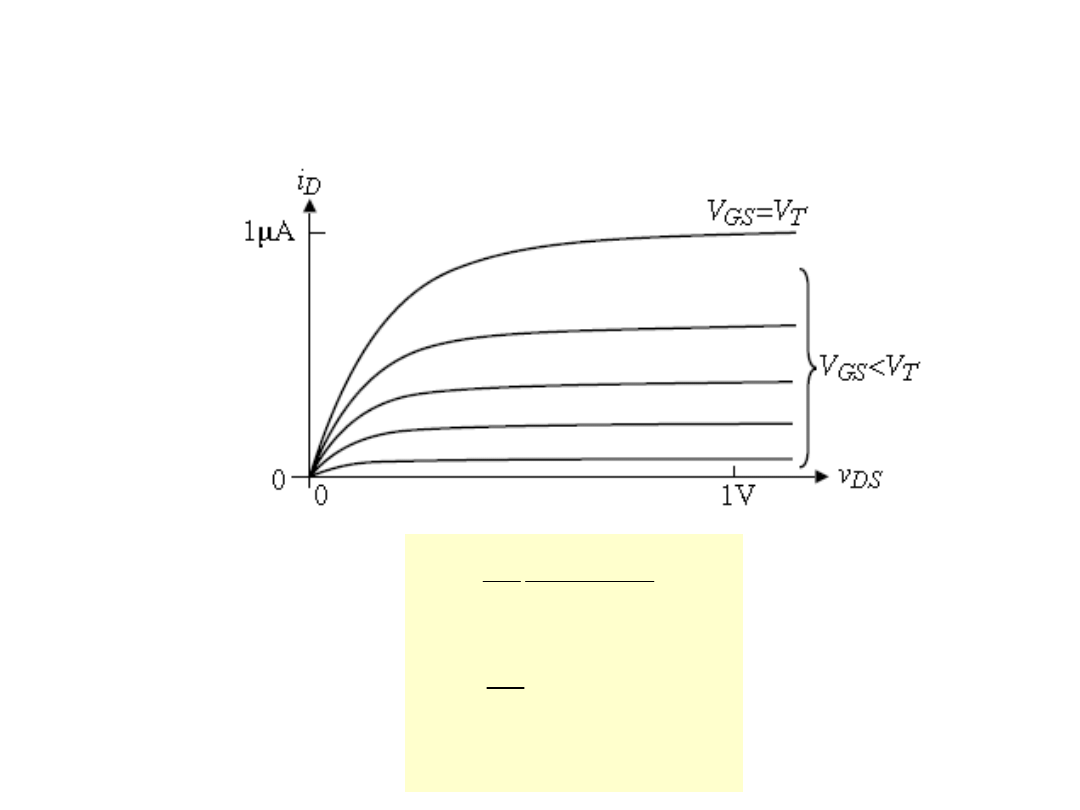
Voltage
Early
A
A
D
ds
jS
ox
ox
t
D
m
V
V
I
g
C
C
C
V
I
g
TRANZYSTOR MOSFET W OBSZARZE SŁABEJ INWERSJI
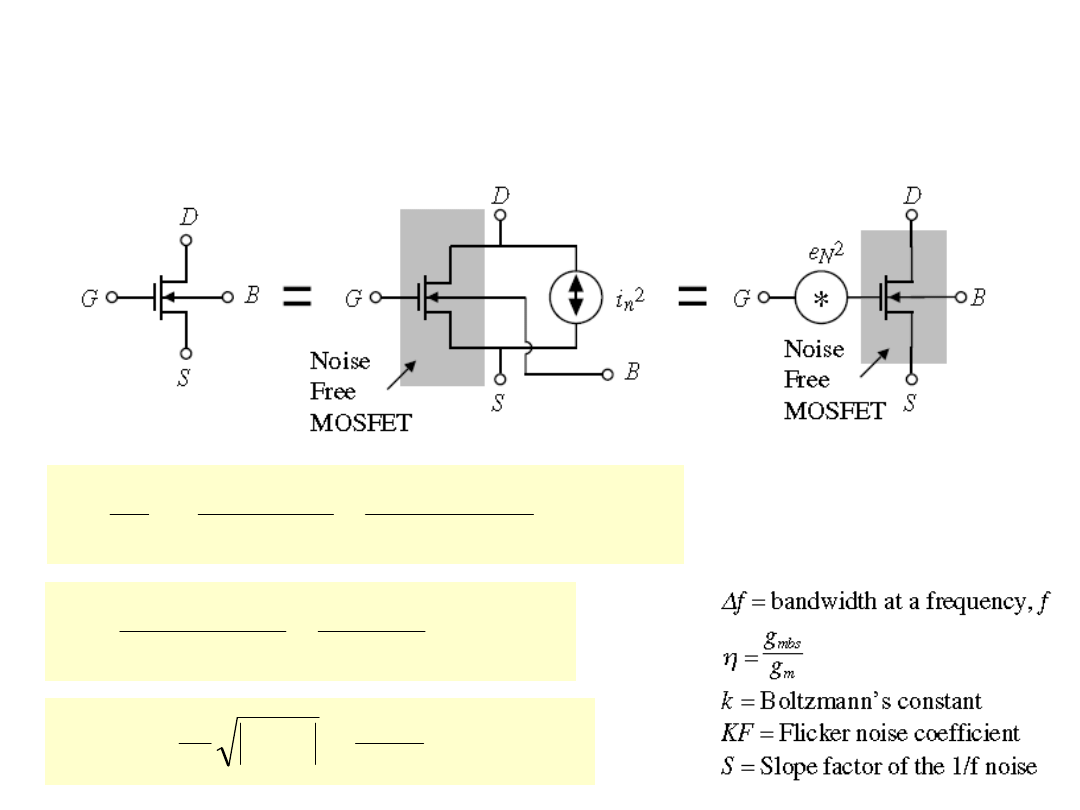
SZUMOWY MODEL TRANZYSTORA
MOSFET
2
'
0
2
2
2
V
2
3
)
1
(
8
f
WLK
C
f
I
K
g
kT
g
i
e
x
s
D
F
m
m
n
n
2
2
0
2
A
3
)
1
(
8
f
L
C
f
I
K
kTg
i
x
s
D
F
m
n
g
K
W
L
I
K W
L
U
U
m
Dsat
GS
T
2 '
'

GĘSTOŚĆ WIDMOWA PRĄDU SZUMÓW
TRANZYSTORA MOSFET

Układy specjalizowane
W i e l k i e s ta n d a r d y
F u l l C u s to m
G a te A r r a y
S ta n d a r d C e l l s
S e m i C u s to m
R e p r o g r a m o w a l n e
P r o g r a m o w a l n e
A S IC
U k ła d y s c a l o n e
Motorola, INTEL,Analog Devices, National
Semiconductors
Application Specific Integrated Circuit
Pełny cykl projektowania, projekt na poziomie masek (layout)
Układ projektowany na zamówienie
matryce bramek
komórki standardowe
Xilinx, Altera (cyfrowe), Zetex (ukł. analogowe!!)
Huta krzemu
(Silicon Foundry)

Strategie projektowania
Up Top
Bottom Down
Hierarchia zadań projektowych wg. stopnia
abstrakcji

Środki CAD w projektowaniu
fizycznym
• Projekt wstępny
• Symulacja przedlayoutowa (SPICE, SMASH, APLAC etc.)
• Projektowanie layoutu (specjalizowany edytor graficzny)
• Weryfikacja reguł geometrycznych. (
DRC - Design Rule
Check)
• Weryfikacja elektrycznych reguł projektowch
(latch up!)
(ERC - Electrical Rule Check)
• Ekstrakcja schematu
(LVS - Layout versus Schematic
Check)
• Końcowa symulacja postlayoutowa (+statystyka!)
(PLS
Post - Layout Simulation)
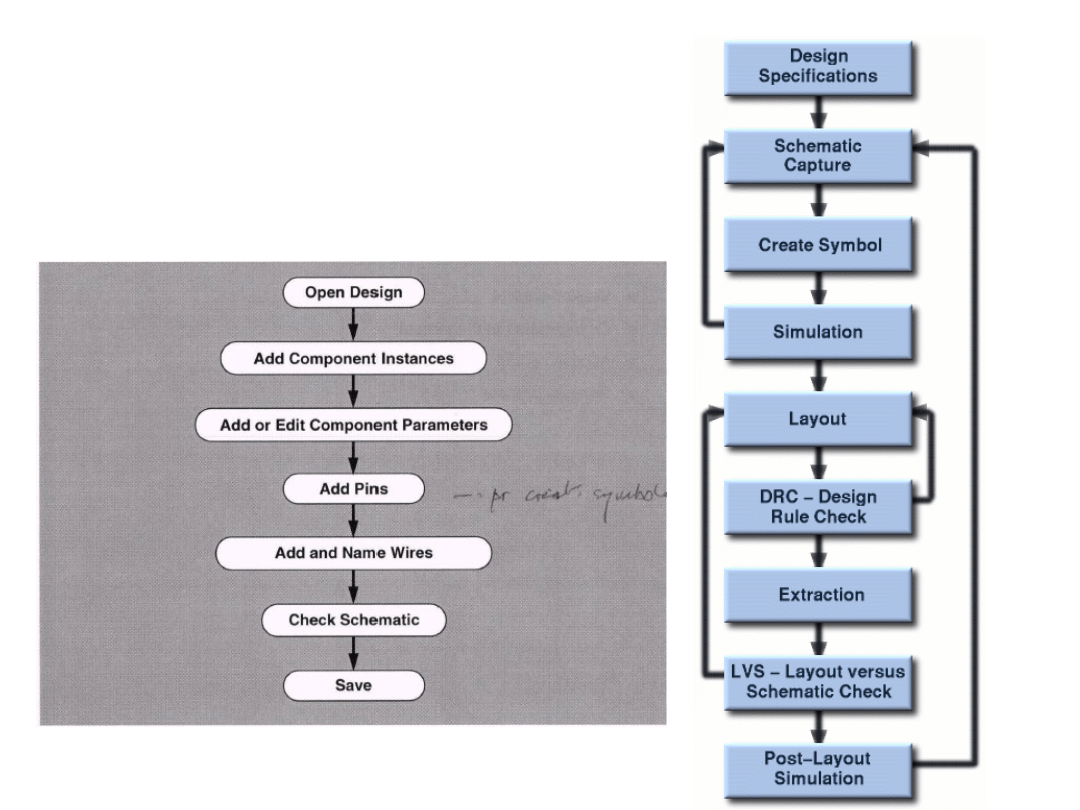
Typowy „design flow”
Schematic
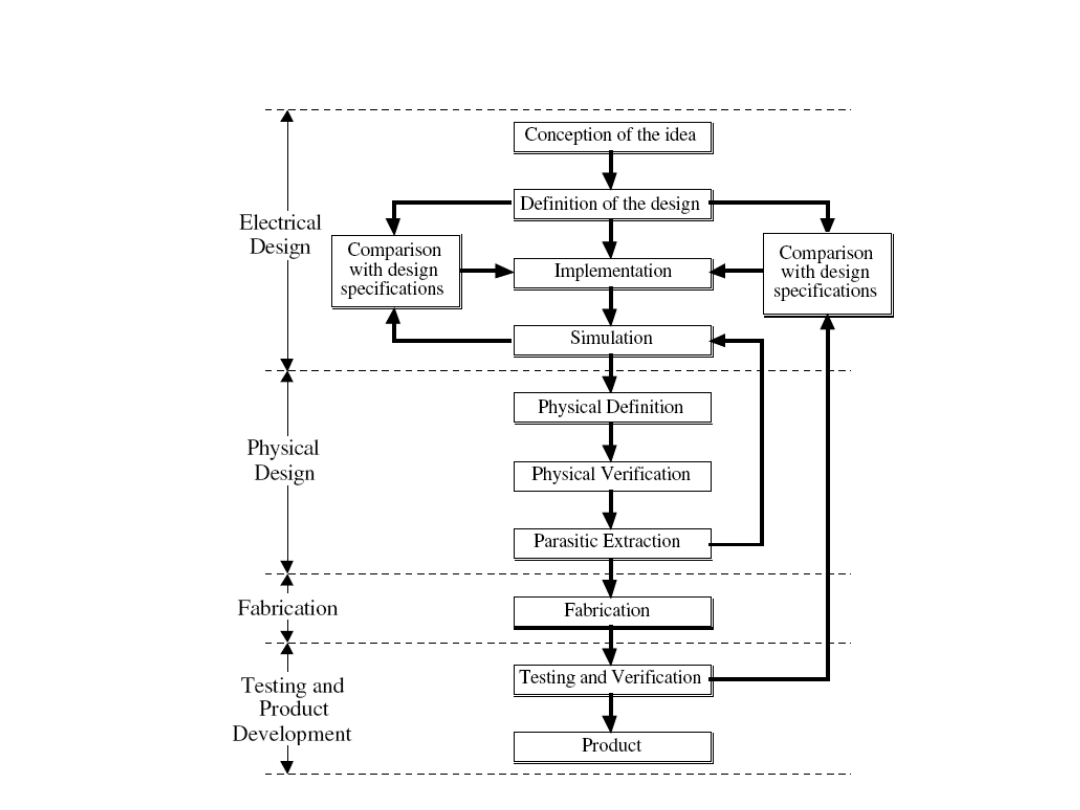
Przebieg projektowania układu analogowego
CMOS

Reguły projektowania (LRS - Layout Rule Specification) dostarczją reguł
projektowania layoutu wraz z parametrami elektrycznymi wszystkich
elementów wykorzystywanych w danej technologii układów scalonych, np.:
0.35um CMOS, C035M-D Alcatel Microelectronics technology, (Alcatel 0.35
um)
0.35um CMOS, C35M-D Austria MicroSystems technology, (AMS 0.35
um),
Mixed mode/RF UMC’s 0.18um CMOS process, (UMC 180 nm)
itd
Przykładowo,
FDK (Foundry Design Kit) UMC 0.18um Cadence-based
Mixed Mode/RF CMOS
dostarcza kompletnych reguł projektowania dla
„front-end and back-end”
*)
zaawansowanej technologii RFIC (Radio
Frequency Integrated Circuits) w środowisku CADENCE.
FDK zapewnia dostęp do wszystkich danych potrzebnych do projektów na
poziomach: projektowania układu (circuit-level design), layoutu i jego
weryfikacji (layout-level design and layout verification ) oraz zapewnia
dostęp do dokładnych modeli wszystkich elementów (accurate RFdevice
models).
*)
Tranzystory MOSFET i pojemności MOS wytwarzane są w podłożu
półprzewodnikowym w kolejnych 7 etapach procesów technologicznych
FEOL - CMOS Front End of Line process , zaś metalowe połączenia,
kontakty oraz indukcyjności wytwarzane są w kolejnych etapach procesów
technologicznych BEOL - CMOS Back End of Line process.
Wyszczególnione etapy procesów technologicznych często nazywa się
„modułami technologicznymi”.

A FDK
(Foundry Design Kit)
contains the process technology
and needed information to do
device-level design in the Cadence
DFII environment.
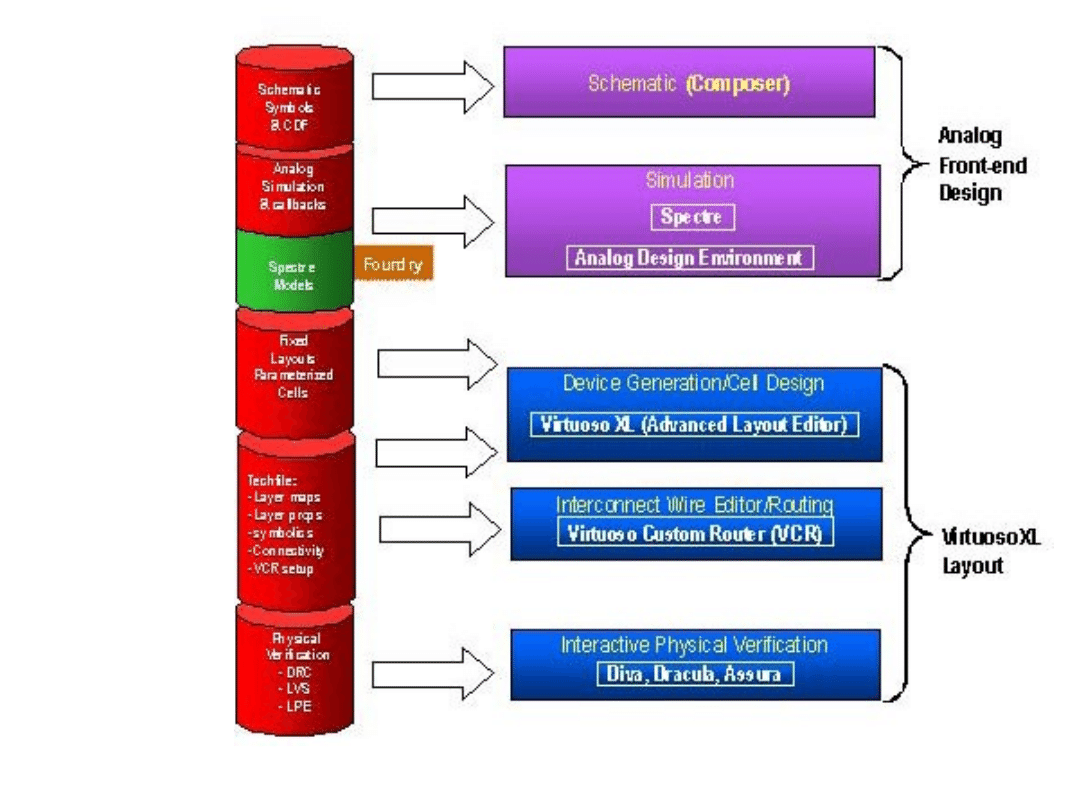
DRC (Design Rule
Check)
(LVS
Layout
versus Schematic
Check)
(PLS Post - Layout
Simulation)
Design Support
Manual
Electrical Design
Rule
Topological
Layout Rule
Spice Modeling
Mask Tooling
DRC Rule Deck
SDL: schematic
driven layout
Document Outline
- Slide 1
- Slide 2
- Slide 3
- Slide 4
- Slide 5
- Slide 6
- Slide 7
- Slide 8
- Slide 9
- Slide 10
- Slide 11
- Slide 12
- Slide 13
- Slide 14
- Slide 15
- Slide 16
- Slide 17
- Slide 18
- Slide 19
- Slide 20
- Slide 21
- Slide 22
- Slide 23
- Slide 24
- Slide 25
- Slide 26
- Slide 27
- Slide 28
- Slide 29
- Slide 30
- Slide 31
- Slide 32
- Slide 33
- Slide 34
- Slide 35
- Slide 36
- Slide 37
- Slide 38
- Slide 39
- Slide 40
- Slide 41
- Slide 42
- Slide 43
- Slide 44
- Slide 45
- Slide 46
Wyszukiwarka
Podobne podstrony:
60 64 IB 7 8 2006 Techn proj cz III
W2 Model kopalni
proj Model (1)
60 64 IB 7 8 2006 Techn proj cz III
Psycholgia wychowawcza W2
mapy do celow proj
R 6 1 Obiektowy model zapytan
model relacyjny
SP dzienni w2
w2 klasy(1)
model komunikacji dwustronnej
W2 Chemiczne skladniki komorki
więcej podobnych podstron