
- 1 -
ZADANIA DO ĆWICZEŃ Z ELEMENTÓW ELEKTRONICZNYCH
temat: Tranzystory MOS – cz. 2
2009.12.14 – 2009.12.18
prowadzący – Piotr Płotka, pplotka@eti.pg.gda.pl, tel. 347-1634, pok. 301
konsultacje: środa 8:00 – 9:00, 13:00 – 14:00
ZADANIE 1.
a) Jakiej najwyższej wartości częstotliwości granicznej f
T
można spodziewać się dla
tranzystora MOS z kanałem typu n, o długości bramki L = 50 nm? Przyjąć, że
długość ścieżki przepływu elektronów wynosi l
n
= 100 nm, a prędkość unoszenia
elektronów w polu elektrycznym równa jest prędkości nasycenia v
sat
= 10
7
cm/s =
10
5
m/s.
b) Jakiej wartości f
T
można by się spodziewać, gdyby ścieżka przepływu elektronów
miała długość bramki L , a ich prędkość unoszenia wynosiła v
driftn
= µ
n
E, gdzie µ
n
=
1000 cm
2
/V·s. Przyjąć wartość nadwyżki napięcia bramka-źródło nad napięciem
progowym V
GS
- V
Tn
= 1 V. Założyć, że tranzystor pracuje w obszarze nasycenia
(pentodowym).
Rozwiązanie:
a) Obliczamy czas przelotu elektronów:
m/s
10
nm
100
5
=
=
sat
n
tn
v
l
t
(1.1)
t
tn
= 10
-12
s.
Szacujemy
częstotliwość graniczną f
T
:
GHz
160
s
10
28
,
6
1
2
1
12
≈
⋅
≈
<
−
tn
T
t
f
π
(1.2)
Uwaga: Długość ścieżki przepływu elektronów l
n
jest około dwukrotnie większa niż
długość bramki L ponieważ części wysoko domieszkowanych obszarów n
+
drenu i
źródła są w znacznym stopniu opróżnione z elektronów przy polaryzacji w zakresie
nasycenia (pentodowym).
b)
Szacujemy częstotliwość graniczną f
T
:
[
]
(
)
L
W
C
V
V
L
W
C
C
C
g
f
ox
Tn
GS
ox
n
gd
gs
m
T
⋅
⋅
⋅
−
⋅
⋅
=
+
<
π
μ
π
2
2
(1.3)
Po
uproszczeniu
(
)
2
2
L
V
V
f
Tn
GS
n
T
⋅
−
⋅
<
π
μ
(1.4)
Podstawiamy
wartości,
(
)
Hz
25
28
,
6
10
Hz
10
25
2π
0,1
nm
50
2π
1V
/Vs
cm
1000
15
16
2
2
⋅
≈
⋅
⋅
≈
⋅
⋅
<
−
T
f
(1.5)

- 2 -
Ostatecznie
f
T
< 6,4·10
12
Hz = 6,4 THz
(1.6)
Komentarz: Oszacowana w ten sposób wielkość f
T
jest wielokrotnie większa od wartości
mierzonej dla tranzystorów z bramkami o długości 50 nm, Mierzone wartości są podobne do
wartości otrzymanej w punkcie a). Błąd szacowania w punkcie b) wynika z przyjęcia
nierealnego założenia, że prędkość unoszenia elektronów jest wprost proporcjonalna do
natężenia pola elektrycznego v
driftn
= µ
n
E. W tranzystorach o najkrótszych produkowanych
dziś długościach kanałów L wartości natężeń pola elektrycznego |
E| są tak duże, że dochodzi
do nasycenia prędkości unoszenia elektronów, jak przyjęto w punkcie a) zadania.
ZADANIE 2.
Dla układu jak na rysunku wyznaczyć górną częstotliwość f
0
pasma przenoszenia
wzmocnienia napięciowego K
V
= V
ds
/E
m
, gdzie V
ds
oraz E
m
są amplitudami napięć
zmiennych. Przyjąć, że C
GG
stanowi zwarcie, a R
GG
stanowi rozwarcie dla składowej
zmiennej. Przyjąć, że tranzystor pracuje w obszarze nasycenia (pentodowym), a elektrony w
kanale poruszaja się z prędkością nasycenia v
sat
= 10
7
cm/s = 10
5
m/s. Pojemność
charakterystyczna C
ox
= 25 fF/µm
2
= 25·10
-3
F/m
2
. Szerokość kanału W = 400 nm, długość
L = 100 nm. Przyjąć, że pojemność tworzona przez przewodzącą elektrodę nad dielektrykiem
bramki dzieli się między źródło a dren w następujący sposób:
C
gs
= 2·L·W·C
ox
/3
(2.1)
C
gd
= L·W·C
ox
/3
(2.2)
Rozwiązanie:
Gdy elektrony poruszają się z prędkością nasycenia natężenie prądu drenu w obszarze
nasycenia można wyrazić zależnością:
I
Ddc
= v
sat
· C
ox
·W·(V
GSdc
- V
Tn
)
(2.3)
Różniczkując tę zależność względem V
GSdc
otrzymujemy wielkość transkonduktancji g
m
W
C
v
V
I
g
ox
sat
const
V
GSdc
Ddc
m
DSdc
⋅
⋅
=
=
=
.
d
d
(2.4)
Po podstawieniu danych
g
m
= 10
5
m/s ·25·10
-3
F/m
2
·400·10
-9
m = 10
-3
A/V = 1 mS
(2.5)
Rys. 2.1

- 3 -
Dla wyznaczenia elementów małosygnałowego schematu zastępczego tranzystora MOS
pozostaje obliczenie wartości pojemności C
gs
oraz C
gd
według zal. 2.1 i zal. 2.2:
C
gs
= 0,66·10
-15
F
(2.6)
C
gd
= 0,33·10
-15
F
(2.7)
Pamiętając, że pojemność C
Z
oraz źródła napięć stałych stanowią zwarcia dla składowych
zmiennych, R
GG
- rozwarcie, otrzymujemy małosygnałowy schemat zastępczy naszego
układu jak na rys. 2.2.
W układzie z rys. 2.2 znamy wartości wszystkich elementów. Możemy zatem wyznaczyć
funkcję przenoszenia K
V
= V
ds
/E
m
w zależności od częstotliwości, czyli również żądaną
wartość częstotliwości bieguna f
0
. J.M. Miller w 1920 r. zaproponował prostszą metodę
obliczania wartości f
0
. W tym celu zauważył, że przy częstotliwości f
0
moduł wzmocnienia
napięciowego pomiędzy punktami G' oraz D jest tylko około 1,41 razy mniejszy niż dla
małych częstotliwości. Dla celu obliczenia prądu I
cgd
płynącego przez pojemność C
gd
Miller
przyjął zatem, że wartość amplitudy napięcia V
ds
jest taka sama, jak dla małych
częstotliwości:
I
cgd
= V
g'd
·C
gd
= (V
g's
- V
ds
) ·C
gd
= j
ω(1+ g
m
·R
o
) ·C
gd
·V
g's
(2.8)
Wartość prądu przedstawionego w zal. (2.8) jest taka sama, jak wartość prądu płynącego
przez pojemność C
M
w układzie przedstawionym na rys.2.3
gdzie
C
M
= (1+ g
m
·R
o
) · C
gd
(2.9)
W układzie przedstawionym na rys. 2.3 obwód wejściowy jest niezależny od obwodu
wyjściowego. Łatwo wyznaczyć częstotliwość bieguna dominującego f
0
analizując obwód
wejściowy.
(
)
[
]
gs
gd
o
m
g
m
s
g
C
C
R
g
R
j
E
V
+
+
⋅
+
=
1
1
)
(
'
ϖ
ω
(2.10)
Stąd wartość częstotliwości bieguna dominującego f
0
Rys. 2.2
Rys. 2.3

- 4 -
(
)
[
]
gs
gd
o
m
g
C
C
R
g
R
f
+
+
⋅
=
1
2
1
0
π
(2.11)
Po podstawieniu danych otrzymujemy
GHz
7
,
3
0
≈
f
(2.12)
Należy jeszcze sprawdzić czy częstotliwość bieguna związanego z obwodem wyjściowym
nie jest mniejsza:
GHz
48
2
1
1
≈
⋅
=
gd
o
C
R
f
π
(2.13)
Widzimy, że nie jest
GHz
48
GHz
7
,
3
0
≈
<
≈
1
f
f
(2.14)
ZADANIE 3.
Tranzystor MOS z indukowanym kanałem typu n pracuje w układzie jak na rys. 3.1. Dla
wartości R = 2 k
Ω, V
SS
= 2,2 V, V
Tn
= 0,2 V oraz
β
n
= µ
n
·C
ox
·W/L = 1 mA/V
2
oblicz
wartości I
Ddc
, V
outdc
oraz amplitudy V
out
.
Rozwiązanie:
Stałoprądowy punkt pracy
Źródło napięcia zmiennego E
m
sin2
πft stanowi zwarcie dla składowej stałej:
V
GSdc
+ I
Sdc
·R – V
SS
= 0
(3.1)
Ale w tranzystorze MOS składowe stałe prądów źródła i drenu są równe
I
Sdc
= I
Ddc
(3.2)
Zatem
V
GSdc
+ I
Ddc
·R – V
SS
= 0
(3.3)
Napięcie V
SS
jest większe niż V
Tn
, więc tranzystor na pewno nie jest odcięty – pracuje w
zakresie nasycenia lub triodowym. Możemy to rozstrzygnąć dostrzegając, że potencjały
bramki i drenu są równe potencjałowi masy, czyli:
V
DGdc
= 0
(3.4)
Rys. 3.1

- 5 -
W warunku pracy tranzystora MOS w obszarze nasycenia
V
DSdc
≥
V
GSdc
- V
Tn
(3.5)
możemy dokonać podstawienia
V
DSdc
= V
GDdc
+ V
GSdc
(3.6)
otrzymując
V
GDdc
+ V
GSdc
≥
V
GSdc
- V
Tn
(3.7)
Przy uwzględnieniu zal. 3.4 dla naszego układu otrzymujemy warunek pracy w obszrze
nasycenia w postaci:
0
+
V
GSdc
≥
V
GSdc
- V
Tn
(3.8)
czyli
0
≥
- V
Tn
(3.9)
Ale dla tranzystora MOS z indukowanym kanałem typu n wartość V
Tn
jest dodatnia, czyli
nierówność w zal. 3.9 jest spełniona. Stąd wniosek, że w układzie z rys. 3.1 tranzystor MOS
z indukowanym kanałem typu n pracuje w obszarze nasycenia o ile tylko V
SS
jest większe niż
V
Tn
, co jest spełnione w naszym przypadku. Prąd drenu można zatem przedstawić jako:
(
)
2
2
Tn
GSdc
n
Ddc
V
V
I
−
⋅
=
β
(3.10)
Z zal. 3.10 i zal. 3.3 otrzymujemy
(
)
2
2
R
I
V
V
I
Ddc
Tn
SS
n
Ddc
−
−
=
β
(3.11)
czyli
(
)
(
)
0
2
2
2
2
2
=
−
+
−
−
−
Tn
SS
Ddc
Tn
SS
n
Ddc
Ddc
V
V
I
V
V
R
I
R
I
β
(3.12)
Rozwiązując to równanie otrzymujemy. Z dwóch rozwiązań tego równania poprawne jest
I
Ddc
=
0,5
mA
(3.13)
Drugie rozwiązanie, 2 mA, odrzucamy ponieważ z zal. 3.1 przy uwzględnieniu zal. 3.2
wynikałoby, ze dla tego rozwiązania V
GSdc
< V
Tn
.
Napięcie wyjściowe
V
out
= -V
GSdc
(3.14)
To napięcie wyznaczamy z zal. 3.1 przy uwzględnieniu zal. 3.2:
V
GSdc
=
1,2
V
(3.15)
V
out
= -V
GSdc
= -1,2 V
(3.16)
Amplituda V
out
Wiedząc, że tranzystor pracuje w obszarze nasycenia i znając wartość V
GSdc
, możemy
wyznaczyć wartość
(
)
Tn
GSdc
n
m
V
V
g
−
=
β
(3.17)
g
m
= 1 mS
(3.18)
i narysować małosygnałowy schemat zastępczy dla małych częstotliwości jak na rys. 3.2.
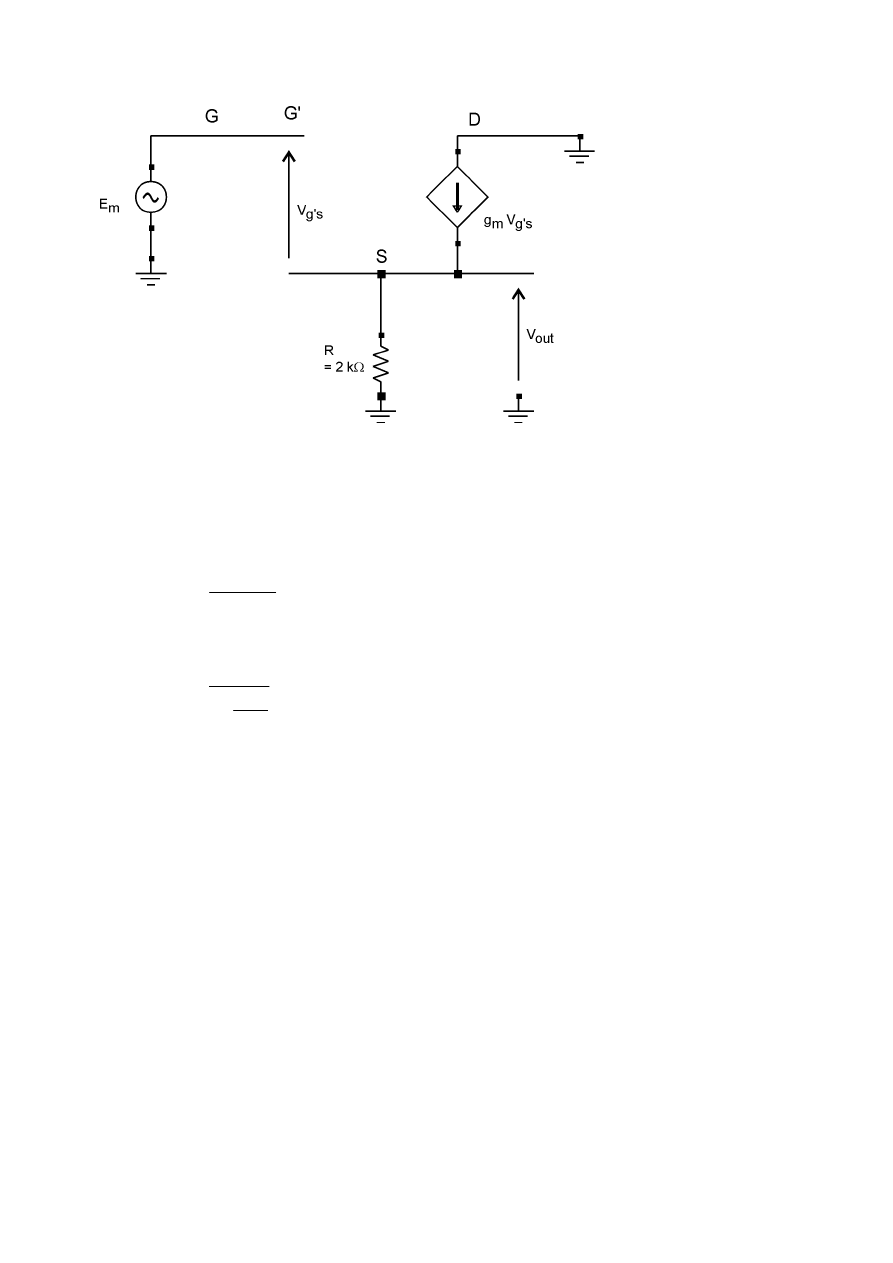
- 6 -
Napięcie V
out
wyrażamy jako
V
out
= g
m
·R·V
g's
(3.19)
Dla oczka obwodu wejściowego
E
m
= V
g's
+ V
out
(3.20)
Z zal. 3.19 i zal. 3.20 otrzymujemy ostatecznie
R
g
E
R
g
V
m
m
m
out
+
⋅
=
1
(3.21)
co można przedstawić jako
R
g
E
V
m
m
out
1
1
+
=
(3.22)
Rys. 3.2
Wyszukiwarka
Podobne podstrony:
Elem Elektron Cwicz Zadania diody 20091130
Elem Elektron Cwicz Zadania BPT
Elem Elektron Cwicz Zadania MOS1
fizyka.org, indukcja elektromagnetyczna, Fizyka - Zadania - Indukcja elektromagnetyczna
Laboratorium z Elektrotechniki ćwicz.7, SPRAWOZDANIA czyjeś
Laboratorium z Elektrotechniki ćwicz.3 wersja DRUGA, SPRAWOZDANIA czyjeś
elektra cwicz 8, UR Elektrotechnika, Ściągi
Elektrotechnika II, Zadania, Część IV
Sprawdzian - Elem. Elektr, sprawdziany, Sprawdziany Fizyka i Powiązane
podstawy elektro rozwiazane zadania wszystkie
Laboratorium z Elektrotechniki ćwicz.13, SPRAWOZDANIA czyjeś
Elektra - same zadania, NAUKA, studia, elektra wykład, word
5Konfiguracja elektronowa atomów zadania do lekcji nr 2
6Konfiguracja elektronowa atomów zadania do lekcji nr 3
4Konfiguracja elektronowa atomów zadania do lekcji nr 1
Zadanie z kompensacji, Elektrotechnika-materiały do szkoły, Gospodarka Sowiński
więcej podobnych podstron